|
Рис. 1. Устройство n-p-n транзистора и его условное обозначение. Биполярные транзисторы, определение, вольт — амперные характеристики, принцип работы и классификация полупроводниковых приборов мы подробно рассматривали на странице http://www.xn--b1agveejs.su/radiotehnika/202-bipolyarnye-tranzistory.html. Для того чтобы усвоить материал, одной статьи мало, две хорошо, а сотни статей еще лучше. В этой статье рассмотрим принцип действия биполярных транзисторов на простом, доступном языке. Биполярный транзистор состоит из двух p-n переходов, образованных слоями полупроводников с примесями. На рис. 1. показана самая простая конструкция n-p-n транзистора. Тонкий слой слабо легированного полупроводника р-типа (база) расположен между двумя более толстыми слоями n-типа (эмиттер и коллектор). Толщина базы может быть меньше одного микрона. Принцип действия биполярного транзистораРис. 2. Иллюстрация работы транзистора: (а) тока базы нет, (б) ток базы течет. На рис. 2. показан транзистор, включенный по схеме с общим эмиттером. В схеме, приведенной на рис. 2.(a), ток базы не течет, а в схеме на рис. 2.(б) переключатель S замкнут, позволяя току из батареи В1 течь в базу транзистора. Сначала рассмотрим схему на рис. 2.(a). Важно отметить, что переход коллектор-база смещен в обратном направлении и имеющийся потенциальный барьер препятствует потоку основных носителей. Таким образом, пренебрегая утечкой, можно считать, что при разомкнутом ключе S коллекторный ток равен нулю. Теперь рассмотрим, что произойдет, когда ключ S замкнут (рис. 2.(б)). Переход база-эмиттер становится смещенным в прямом направлении, а переход коллектор-база остается смещенным в обратном направлении. Благодаря смещению перехода база-эмиттер в прямом направлении электроны из эмиттера n-типа посредством диффузии проходят по базе р-типа по направлению к обедненному слою на переходе база-коллектор. Следующий момент требует объяснения. Почему электроны не рекомбинируют с дырками в базе р-типа в процессе диффузии в сторону коллектора? Ответ состоит в том, что базу делают совсем слабо легированной, то есть с низкой концентрацией дырок, и очень тонкой; следовательно, имеется лишь малая вероятность того, что электрон будет перехвачен дыркой и рекомбинирует. Когда электрон рекомбинирует в области базы, происходит кратковременное нарушение равновесия, поскольку база приобретает отрицательный заряд. Равновесие восстанавливается с приходом дырки из базовой батареи В1 Батарея В1 является источником дырок для компенсации рекомбинирующих в базе, и эти дырки образуют базовый ток транзистора. Фактически в работе транзистора принимают участие как электроны, так и дырки, что отличает его от униполярного или полевого транзистора. Ранее упоминалось, что при смещении p-n перехода в прямом направлении текущий по нему ток образуют как электроны, так и дырки. Но при рассмотрении смещенного в прямом направлении перехода база-эмиттер мы пока учитывали только электроны, пересекающие этот переход. Эффекты второго порядка. Зависимость коллекторного тока от тока базыРис. 3. Типичная зависимость коллекторного тока от тока базы в маломощном кремниевом транзисторе. На рис. При очень больших токах коллектора, когда заселенность базы дырками становится слишком большой, усиление начинает падать. База ведет себя так, как будто она легирована сильнее, чем это есть в действительности, так что значительная часть тока, текущего через эмиттерный переход, состоит из дырок, движущихся из базы в эмиттер так же, как полезные электроны, двигающиеся в другом направлении, к коллектору. Таким образом, все большая и большая часть базового тока является «пустой породой» и поэтому коэффициент усиления тока падает. Этот эффект важен в мощных усилителях, где он может приводить к искажению формы сигнала при больших токах коллектора. В связи с тем, что зависимость коллекторного тока от тока базы является нелинейной, существуют два определения для коэффициента усиления тока транзистора в схеме с общим эмиттером. Коэффициент усиления постоянного тока получается просто делением тока коллектора на ток базы; его обозначают hFE В или β и он важен для переключающих схем. hfe=ΔIC/ΔIB. Для большинства практических целей можно считать, что hFE и hfe равны. Ток утечки между коллектором и базойХотя переход коллектор-база смещен в обратном направлении, все же существует очень небольшой ток утечки из коллектора в базу, обозначаемый ICBO поскольку он измеряется с разомкнутой цепью эмиттера. В кремниевом транзисторе при комнатной температуре ICBO очень мал, обычно менее 0,01 мкА. Однако в случае, когда транзистор включен в схему с общим эмиттером и цепь базы разорвана, как показано на рис. Когда кремниевый транзистор работает при комнатной температуре, токами I CBO и ICEO можно практически полностью пренебречь. В германиевом транзисторе при комнатной температуре (20 °С) ток ICBO имеет значение порядка 2 мкА, так что при hFE = 100 ток ICEO будет равен 200 мкА. n-p-n и p-n-p транзисторыОписание работы транзистора, данное выше, относится к наиболее распространенным n-р-n транзисторам; также легко доступны р-n-р транзисторы, очень полезные для целого ряда комплементарных схем, так как они обладают характеристиками, идентичными с n-р-n транзисторами, но требуют напряжения питания противоположной полярности. Тогда как в n-р-n транзисторе ток коллектора состоит из электронов, в р-n-р транзисторе он состоит из дырок. Аналогично, ток базы является электронным током, а не дырочным. На рис. 4. показана структура р-n-р транзистора и его условное обозначение. Рис. 4. Устройство р-n-р транзистора и его условное обозначение.
Материалы по теме: |
полевой транзистор — Translation into English — examples Russian
These examples may contain rude words based on your search.
These examples may contain colloquial words based on your search.
Отрицательное напряжение базы будет удерживать ключ (например биполярный NPN-транзистор или N-канальный полевой транзистор) разомкнутым, и это будет длиться до тех пор, пока вся энергия уменьшающегося магнитного потока не будет поглощена (чем-нибудь).
A negative control voltage will maintain the switch (e.g. NPN bipolar transistor or N-channel FET)open, and this situation will persist until the energy of the collapsing flux has been absorbed (by something).Каждый полевой транзистор состоит из канала в полупроводниковой подложке устройства.
В качестве ключа, через который подаются импульсы тока на нагрузку, применяется мощный полевой транзистор.
Suggest an example
Other results
Это можно увидеть по сигналу на стоке полевого транзистора.
Изобретение относится к гетероструктурам полупроводниковых приборов, главным образом, полевых транзисторов.
Органические полевые транзисторы и интегральные схемы могут быть полностью изготовлены с помощью серийных методов печати.
Торкл Уолмарк и Харвик Джонсон (RCA) работали и с тиристорами, и с полевыми транзисторами.
Впоследствии учёный оптимизировал дизайн и производительность полевых транзисторов на основе УНТ, что позволило им превзойти кремниевые устройства.
Subsequently, he optimized the design and performance of the CNT field-effect transistors, enabling them to outperform silicon devices.Каждый бит памяти EPROM состоит из одного полевого транзистора.
Задачей настоящего изобретения является увеличение проводимости канального слоя полупроводниковой гетероструктуры и, следовательно, увеличение рабочих токов и мощности полевых транзисторов.
The aim of the invention is to increase the conductivity of the channel layer of a semiconductor heterostructure and, thereby to increase working currents and power of the field-effect transistors.
Wide Field Imager Данный инструмент является рентгеновским спектрометром, состоящим из 5 массивов полевых транзисторов с переходами p-типа и диапазоном регистрируемого излучения 0,1-15 кэВ.
Wide Field Imager The Wide Field Imager (WFI) is an X-ray spectrometer utilizing five arrays of p-channel field-effect transistors with a detection range of 0.1-15 keV.Более того, возможно прямое электрическое определение небольших пептидов и белков по характерному для них заряду, используя биологически модифицированные ион-селективные полевые транзисторы (ИСПТ).
Further, the label-free and direct electrical detection of small peptides and proteins is possible by their intrinsic charges using biofunctionalized ion-sensitive field-effect transistors.
Достижения в изготовлении полупроводников и постоянно растущий спрос на более быстрые и сложные интегральные схемы (ИС) привёл к появлению полевых транзисторов с МОП-структурой, масштабированных к малым размерам.
Advances in semiconductor manufacturing techniques and ever increasing demand for faster and more complex integrated circuits (ICs) have driven the associated Metal-Oxide-Semiconductor field-effect transistor (MOSFET) to scale to smaller dimensions.
Это привело к коммерциализации высокопроизводительных синих светодиодов и долгосрочной жизни фиолетово-лазерных диодов, а также дало развитие устройств на основе нитридов, таких как детекторы УФ и высокоскоростных полевых транзисторов.
This has led to the commercialization of high-performance blue LEDs and long-lifetime violet-laser diodes, and to the development of nitride-based devices such as UV detectors and high-speed field-effect transistors.
После обустройства Шокли сосредоточил усилия на доводке до серийного выпуска динисторов (четырёхслойных диодов, диодов Шокли), а пять сотрудников во главе с Нойсом продолжили работу над полевым транзистором для Beckman Instruments.
After resettlement, he focused on fine-tuning Shockley diodes for mass production, and five employees, led by Noyce, continued the work on a field effect transistor for Beckman Instruments.Этот универсальный и сравнительно простой метод используется в основном для проводящих и диэлектрических слоев, а также для органических полупроводников, и даже для органических полевых транзисторов (OFET).
This versatile and comparatively simple method is used mainly for conductive and dielectric layers, but also organic semiconductors, e. g. for OPVCs, and even complete OFETs can be printed.
g. for OPVCs, and even complete OFETs can be printed.
Универсальный датчик представляет собой полевой или IGBT транзистор, включенный в диагональ диодного моста.
A multipurpose sensor is in the form of a field-effect transistor or an IGBT which is connected into a diagonal of a diode bridge.Так, как полевой и IGBT транзистор обладают высоким входным сопротивлением, то через устройство коммутации протекает малый ток, и это повышает надежность его работы.
Since field-effect transistors and IGBTs have a high input resistance, a low current flows through the switching device, and this increases the operational reliability of said switching device.60 лет транзистору
Б. М. Малашевич
М. Малашевич
Трудно найти такую отрасль науки и техники, которая так же стремительно развивалась и оказала такое–же огромное влияние на все стороны жизнедеятельности человека, каждого отдельного и общества в целом, как электроника.
Как самостоятельное направление науки и техники электроника сформировалась благодаря электронной лампе. Сначала появились радиосвязь, радиовещание, радиолокация, телевидение, затем электронные системы управления, вычислительная техника и т.п. Но электронная лампа имеет неустранимые недостатки: большие габариты, высокое энергопотребление, большое время вхождения в рабочий режим, низкую надежность. В результате через 2-3 десятка лет существования ламповая электроника во многих применениях подошла к пределу своих возможностей. Электронной лампе требовалась более компактная, экономичная и надежная замена. И она нашлась в виде полупроводникового транзистора. Его создание справедливо считают одним из величайших достижений научно-технической мысли двадцатого столетия, коренным образом изменившим мир. Оно было отмечено Нобелевской премией по физике, присужденной в 1956 г. американцам Джону Бардину, Уолтеру Браттейну и Уильяму Шокли. Но у нобелевской тройки в разных странах были предшественники .
Оно было отмечено Нобелевской премией по физике, присужденной в 1956 г. американцам Джону Бардину, Уолтеру Браттейну и Уильяму Шокли. Но у нобелевской тройки в разных странах были предшественники .
И это понятно. Появление транзисторов – результат многолетней работы многих выдающихся ученых и специалистов, которые в течении предшествующих десятилетий развивали науку о полупроводниках. Советские ученые внесли в это общее дело огромный вклад. Очень много было сделано школой физики полупроводников академика А.Ф. Иоффе – пионера мировых исследований по физике полупроводников. Еще в 1931 году он опубликовал статью с пророческим названием: «Полупроводники – новые материалы электроники». Немалую заслугу в исследование полупроводников внесли Б.В. Курчатов и В.П. Жузе. В своей работе – «К вопросу об электропроводности закиси меди» в 1932 году они показали, что величина и тип электрической проводимости определяется концентрацией и природой примеси. Советский физик Я.Н. Френкель создал теорию возбуждения в полупроводниках парных носителей заряда: электронов и дырок. В 1931 г. англичанину Уилсону удалось создать т еоретическую модель полупроводника, сформулировав при этом основы «зонной теории полупроводников». В 1938 г. Мотт в Англии, Б.Давыдов в СССР, Вальтер Шоттки в Германии независимо друг от друга предложили теорию выпрямляющего действия контакта металл-полупроводник. В 1939 году Б.Давыдов опубликовал работу «Диффузионная теория выпрямления в полупроводниках». В 1941 г. В. Е. Лашкарев опубликовал статью «Исследование запирающих слоев методом термозонда» и в соавторстве с К. М. Косоноговой – статью «Влияние примесей на вентильный фотоэффект в закиси меди». Он описал физику «запорного слоя» на границе раздела «медь – закись меди», впоследствии названного «p-n» переходом. В 1946 г. В. Лошкарев открыл биполярную диффузию неравновесных носителей тока в полупроводниках. Им же был раскрыт механизм инжекции – важнейшего явления, на основе которого действуют полупроводниковые диоды и транзисторы. Большой вклад в исследование свойств полупроводников внесли И.
В 1931 г. англичанину Уилсону удалось создать т еоретическую модель полупроводника, сформулировав при этом основы «зонной теории полупроводников». В 1938 г. Мотт в Англии, Б.Давыдов в СССР, Вальтер Шоттки в Германии независимо друг от друга предложили теорию выпрямляющего действия контакта металл-полупроводник. В 1939 году Б.Давыдов опубликовал работу «Диффузионная теория выпрямления в полупроводниках». В 1941 г. В. Е. Лашкарев опубликовал статью «Исследование запирающих слоев методом термозонда» и в соавторстве с К. М. Косоноговой – статью «Влияние примесей на вентильный фотоэффект в закиси меди». Он описал физику «запорного слоя» на границе раздела «медь – закись меди», впоследствии названного «p-n» переходом. В 1946 г. В. Лошкарев открыл биполярную диффузию неравновесных носителей тока в полупроводниках. Им же был раскрыт механизм инжекции – важнейшего явления, на основе которого действуют полупроводниковые диоды и транзисторы. Большой вклад в исследование свойств полупроводников внесли И. В.Курчатов, Ю.М.Кушнир, Л.Д.Ландау, В.М.Тучкевича, Ж.И.Алферов и др. Таким образом, к концу сороковых годов двадцатого века основы теоретической базы для создания транзисторов были проработаны достаточно глубоко, чтобы приступать к практическим работам.
В.Курчатов, Ю.М.Кушнир, Л.Д.Ландау, В.М.Тучкевича, Ж.И.Алферов и др. Таким образом, к концу сороковых годов двадцатого века основы теоретической базы для создания транзисторов были проработаны достаточно глубоко, чтобы приступать к практическим работам.
Рис. Транзитрон Г.Матаре и Г.Велкера
Первой известной попыткой создания кристаллического усилителя в США предпринял немецкий физик Юлиус Лилиенфельд, запатентовавший в 1930, 1932 и 1933 гг. три варианта усилителя на основе сульфида меди. В 1935 г. немецкий у ченый Оскар Хейл получил британский патент на усилитель на основе пятиокиси ванадия. В 1938 г. немецкий физик Поль создал действующий образец кристаллического усилителя на нагретом кристалле бромида калия. В довоенные годы в Германии и Англии было выдано еще несколько аналогичных патентов. Эти усилители можно считать прообразом современных полевых транзисторов. Однако построить устойчиво работающие приборы не удавалось, т.к. в то время еще не было достаточно чистых материалов и технологий их обработки. В первой половине тридцатых годов точечные триоды изготовили двое радиолюбителей – канадец Ларри Кайзер и тринадцатилетний новозеландский школьник Роберт Адамс. В июне 1948 г. (до обнародования транзистора) изготовили свой вариант точечного германиевого триода, названный ими транзитроном, жившие тогда во Франции немецкие физики Роберт Поль и Рудольф Хилш. В начале 1949 г. было организовано производство транзитронов, применялись они в телефонном оборудовании, причем работали лучше и дольше американских транзисторов. В России в 20-х годах в Нижнем Новгороде О.В.Лосев наблюдал транзисторный эффект в системе из трех – четырех контактов на поверхности кремния и корборунда. В середине 1939 г. он писал: «…с полупроводниками может быть построена трехэлектродная система, аналогичная триоду», но увлекся открытым им светодиодным эффектом и не реализовал эту идею. К транзистору вело множество дорог.
В первой половине тридцатых годов точечные триоды изготовили двое радиолюбителей – канадец Ларри Кайзер и тринадцатилетний новозеландский школьник Роберт Адамс. В июне 1948 г. (до обнародования транзистора) изготовили свой вариант точечного германиевого триода, названный ими транзитроном, жившие тогда во Франции немецкие физики Роберт Поль и Рудольф Хилш. В начале 1949 г. было организовано производство транзитронов, применялись они в телефонном оборудовании, причем работали лучше и дольше американских транзисторов. В России в 20-х годах в Нижнем Новгороде О.В.Лосев наблюдал транзисторный эффект в системе из трех – четырех контактов на поверхности кремния и корборунда. В середине 1939 г. он писал: «…с полупроводниками может быть построена трехэлектродная система, аналогичная триоду», но увлекся открытым им светодиодным эффектом и не реализовал эту идею. К транзистору вело множество дорог.
Первый транзистор
Слава направо: Уильям Шокли,
Джон Бардин (сидит), Уолтер Бреттейн.
Фото из http://gete.ru/page_140.html
Выше описанные примеры проектов и образцов транзисторов были результатами локальных всплесков мысли талантливых или удачливых людей, не подкрепленные достаточной экономической и организационной поддержкой и не сыгравшие серьезной роли в развитии электроники. Дж. Бардин, У. Браттейн и У. Шокли оказались в лучших условиях. Они работали по единственной в мире целенаправленной долговременной (более 5 лет) программе с достаточным финансовым и материальным обеспечением в фирме Bell Telephone Laboratories, тогда одной из самых мощных и наукоемких в США. Их работы были начаты еще во второй половине тридцатых годов, работу возглавил Джозеф Бекер, который привлек к ней высококлассного теоретика У. Шокли и блестящего экспериментатора У. Браттейна. В 1939 г. Шокли выдвинул идею изменять проводимость тонкой пластины полупроводника (оксида меди), воздействуя на нее внешним электрическим полем. Это было нечто, напоминающее и патент Ю. Лилиенфельда, и позже сделанный и ставший массовым полевой транзистор. В 1940 г. Шокли и Браттейн приняли удачное решение ограничить исследования только простыми элементами – германием и кремнием. Однако все попытки построить твердотельный усилитель ни к чему не привели, и после Пирл-Харбора (практическое начало Второй мировой войны для США) были положены в долгий ящик. Шоккли и Браттейн были направлены в исследовательский центр, работавший над созданием радаров. В 1945 г. оба возвратились в Bell Labs. Там под руководством Шокли была создана сильная команда из физиков, химиков и инженеров для работы над твердотельными приборами. В нее вошли У. Браттейн и физик-теоретик Дж. Бардин. Шокли сориентировал группу на реализацию своей довоенной идеи. Но устройство упорно отказывалось работать, и Шокли, поручив Бардину и Браттейну довести его до ума, сам практически устранился от этой темы.
В 1940 г. Шокли и Браттейн приняли удачное решение ограничить исследования только простыми элементами – германием и кремнием. Однако все попытки построить твердотельный усилитель ни к чему не привели, и после Пирл-Харбора (практическое начало Второй мировой войны для США) были положены в долгий ящик. Шоккли и Браттейн были направлены в исследовательский центр, работавший над созданием радаров. В 1945 г. оба возвратились в Bell Labs. Там под руководством Шокли была создана сильная команда из физиков, химиков и инженеров для работы над твердотельными приборами. В нее вошли У. Браттейн и физик-теоретик Дж. Бардин. Шокли сориентировал группу на реализацию своей довоенной идеи. Но устройство упорно отказывалось работать, и Шокли, поручив Бардину и Браттейну довести его до ума, сам практически устранился от этой темы.
Два года упорного труда принесли лишь отрицательные результаты. Бардин предположил, что избыточные электроны прочно оседали в приповерхностных областях и экранировали внешнее поле. Эта гипотеза подсказала дальнейшие действия. Плоский управляющий электрод заменили острием, пытаясь локально воздействовать на тонкий приповерхностный слой полупроводника.
Эта гипотеза подсказала дальнейшие действия. Плоский управляющий электрод заменили острием, пытаясь локально воздействовать на тонкий приповерхностный слой полупроводника.
Первый транзистор У. Браттейна и Дж. Бардина
Однажды Браттейн нечаянно почти вплотную сблизил два игольчатых электрода на поверхности германия, да еще перепутал полярность напряжений питания, и вдруг заметил влияние тока одного электрода на ток другого. Бардин мгновенно оценил ошибку. А 16 декабря 1947 г. у них заработал твердотельный усилитель, который и считают первым в мире транзистором. Устроен он был очень просто – на металлической подложке-электроде лежала пластинка германия, в которую упирались два близко расположенных (10-15 мкм) контакта. Оригинально были сделаны эти контакты. Треугольный пластмассовый нож, обернутый золотой фольгой, разрезанной надвое бритвой по вершине треугольника. Треугольник прижимался к германиевой пластинке специальной пружиной, изготовленной из изогнутой канцелярской скрепки.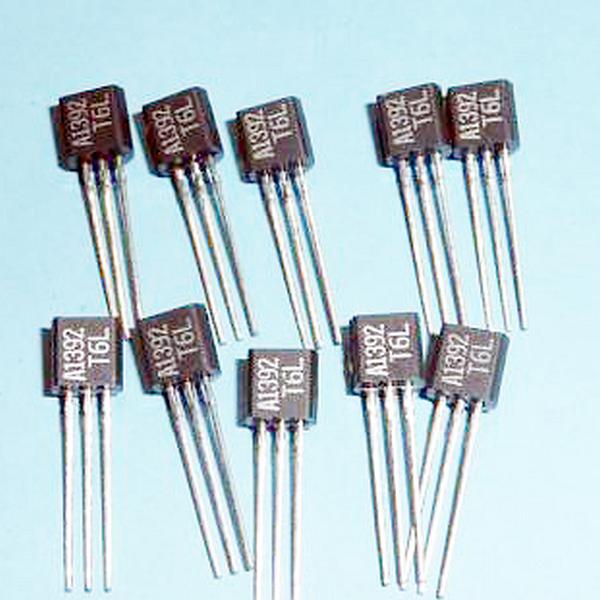 Через неделю, 23 декабря 1947 г. прибор был продемонстрирован руководству фирмы, этот день и считается датой рождения транзистора. Все были рады результатом, кроме Шокли: получилось, что он, раньше всех задумавший полупроводниковый усилитель, руководивший группой специалистов, читавший им лекции по квантовой теории полупроводников – не участвовал в его создании. Да и транзистор получился не такой, как Шокли задумывал: биполярный, а не полевой. Следовательно на соавторство в «звездном» патенте он претендовать не мог.
Через неделю, 23 декабря 1947 г. прибор был продемонстрирован руководству фирмы, этот день и считается датой рождения транзистора. Все были рады результатом, кроме Шокли: получилось, что он, раньше всех задумавший полупроводниковый усилитель, руководивший группой специалистов, читавший им лекции по квантовой теории полупроводников – не участвовал в его создании. Да и транзистор получился не такой, как Шокли задумывал: биполярный, а не полевой. Следовательно на соавторство в «звездном» патенте он претендовать не мог.
Прибор работал, но широкой публике эту внешне несуразную конструкцию показывать было нельзя. Изготовили несколько транзисторов в виде металлических цилиндриков диаметром около 13 мм. и собрали на них «безламповый» радиоприемник. 30 июня 1948 г. в Нью-Йорке состоялась официальная презентация нового прибора – транзистора (от англ. Transver Resistor – трансформатор сопротивлений). Но специалисты не сразу оценили его возможности. Эксперты из Пентагона «приговорили» транзистор к использованию лишь в слуховых аппаратах для старичков.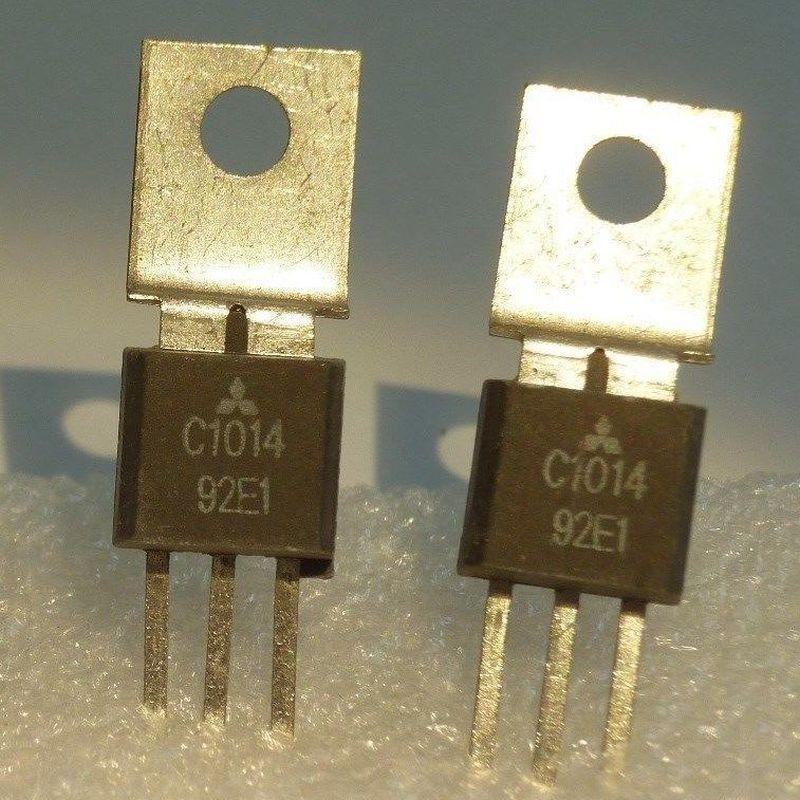 Так близорукость военных спасла транзистор от засекречивания. Презентация осталась почти незамеченной, лишь пара абзацев о транзисторе появилась в «Нью-Йорк Тайме» на 46 странице в разделе «Новости радио». Таким было явление миру одного из величайших открытий XX века. Даже изготовители электронных ламп, вложившие многие миллионы в свои заводы, в появлении транзистора угрозы не увидели.
Так близорукость военных спасла транзистор от засекречивания. Презентация осталась почти незамеченной, лишь пара абзацев о транзисторе появилась в «Нью-Йорк Тайме» на 46 странице в разделе «Новости радио». Таким было явление миру одного из величайших открытий XX века. Даже изготовители электронных ламп, вложившие многие миллионы в свои заводы, в появлении транзистора угрозы не увидели.
Позже, в июле 1948 года, информация об этом изобретении появилась в журнале «The Physical Review». Но т олько через некоторое в ремя специалисты поняли, что произошло грандиозное событие, определившее дальнейшее развитие прогресса в мире.
Bell Labs сразу оформила патент на это революционное изобретение, но с технологией было масса проблем. Первые транзисторы, поступившие в продажу в 1948 году, не внушали оптимизма – стоило их потрясти, и коэффициент усиления менялся в несколько раз, а при нагревании они и вовсе переставали работать. Но зато им не было равных в миниатюрности. Аппараты для людей с пониженным слухом можно было поместить в оправе очков! Поняв, что вряд ли она сама сможет справиться со всеми технологическими проблемами, Bell Labs решилась на необычный шаг. В начале 1952 года она объявила, что полностью передаст права на изготовление транзистора всем компаниям, готовым выложить довольно скромную сумму в 25 000 долларов вместо регулярных выплат за пользование патентом, и предложила обучающие курсы по транзисторной технологии, помогая распространению технологии по всему миру. Постепенно росла очевидность важности этого миниатюрного устройства. Транзистор оказался привлекательным по следующим причинам: был дешев, миниатюрен, прочен, потреблял мало мощности и мгновенно включался (лампы долго нагревались). В 1953 г. на рынке появилось первое коммерческое транзисторное изделие – слуховой аппарат (пионером в этом деле выступил Джон Килби из ф. Centralab , который через несколько лет сделает первую в мире полупроводниковую микросхему), а в октябре 1954 г. – первый транзисторный радиоприе мник Regency TR1, в нем использовалось всего четыре германиевых транзистора. Немедленно принялась осваивать новые приборы и индустрия вычислительной техники, первой была фирма IBM .
В начале 1952 года она объявила, что полностью передаст права на изготовление транзистора всем компаниям, готовым выложить довольно скромную сумму в 25 000 долларов вместо регулярных выплат за пользование патентом, и предложила обучающие курсы по транзисторной технологии, помогая распространению технологии по всему миру. Постепенно росла очевидность важности этого миниатюрного устройства. Транзистор оказался привлекательным по следующим причинам: был дешев, миниатюрен, прочен, потреблял мало мощности и мгновенно включался (лампы долго нагревались). В 1953 г. на рынке появилось первое коммерческое транзисторное изделие – слуховой аппарат (пионером в этом деле выступил Джон Килби из ф. Centralab , который через несколько лет сделает первую в мире полупроводниковую микросхему), а в октябре 1954 г. – первый транзисторный радиоприе мник Regency TR1, в нем использовалось всего четыре германиевых транзистора. Немедленно принялась осваивать новые приборы и индустрия вычислительной техники, первой была фирма IBM . Доступность технологии дала свои плоды – мир начал стремительно меняться.
Доступность технологии дала свои плоды – мир начал стремительно меняться.
Польза конструктивного честолюбия
У честолюбивого У.Шокли случившееся вызвало вулканический всплеск его творческой энергии. Хотя Дж. Бардин и У.Браттейн нечаянно получили не полевой транзистор, как планировал Шокли, а биполярный, он быстро разобрался в сделанном. Позднее Шокли вспоминал о своей «страстной неделе», в течение которой он создал теорию инжекции, а в новогоднюю ночь изобрел плоскостной биполярный транзистор без экзотических иголочек.
Что бы создать что-то новое, Шокли по-новому взглянул на давно известное – на точечный и плоскостный полупроводниковые диоды, на физику работы плоскостного «p — n» перехода, легко поддающуюся теоретическому анализу. Поскольку точечный транзистор представляет собой два очень сближенные диода, Шокли провел теоретическое исследования пары аналогично сближенных плоскостных диодов и создал основы теории плоскостного биполярного транзистора в кристалле полупроводника, со держащего два «p — n» перехода. Плоскостные транзисторы обладают рядом преимуществ перед точечными: они более доступны теоретическому анализу, обладают более низким уровнем шумов, обеспечивают большую мощность и, главное, более высокие повторяемость параметров и надежность. Но, пожалуй, главным их преимуществом была легко автоматизируемая технология, исключающая сложные операции изготовления, установки и позиционирования подпружиненных иголочек, а также обеспечивавшая дальнейшую миниатюризацию приборов.
Плоскостные транзисторы обладают рядом преимуществ перед точечными: они более доступны теоретическому анализу, обладают более низким уровнем шумов, обеспечивают большую мощность и, главное, более высокие повторяемость параметров и надежность. Но, пожалуй, главным их преимуществом была легко автоматизируемая технология, исключающая сложные операции изготовления, установки и позиционирования подпружиненных иголочек, а также обеспечивавшая дальнейшую миниатюризацию приборов.
30 июня 1948 г. в нью-йоркском офисе Bell Labs изобретение было впервые продемонстрировано руководству компании. Но оказалось, что создать серийноспособный плоскостной транзистор гораздо труднее, чем точечный. Транзистор Браттейна и Бардина – чрезвычайно простое устройство. Его единственным полупроводниковым компонентом был кусочек относительно чистого и вполне тогда доступного германия. А вот техника легирования полупроводников в конце сороковых годов, необходимая для изготовления плоскостного транзистора, еще находилась в младенчестве, поэтому изготовление серийноспособного транзистора «по Шокли» удалось только в 1951 г. В 1954 году Bell Labs разработала процессы окисления, фотолитографии, диффузии, которые на многие годы стали основой производства полупроводниковых приборов.
В 1954 году Bell Labs разработала процессы окисления, фотолитографии, диффузии, которые на многие годы стали основой производства полупроводниковых приборов.
Первый кремниевый транзистор, 1950 г.
Точечный транзистор Бардина и Браттейна – безусловно огромный прогресс по сравнению с электронными лампами. Но не он стал основой микроэлектроники, век его оказался короток, около 10 лет. Шокли быстро понял сделанное коллегами и создал плоскостной вариант биполярного транзистора, который жив и сегодня и будет жить, пока существует микроэлектроника. Патент на него он получил в 1951 г. А в 1952 г. У. Шокли создал и поле вой транзистор, так же им запатентованный. Так что свое участие в Нобелевской премии он заработал честно.
Число производителей транзисторов росло как снежный ком. Bell Labs, Shockley Semiconductor, Fairchild Semiconductor, Western Electric, GSI (с декабря 1951 г. Texas Instruments), Motorola, Tokyo Cousin (С 1958 г. Sony), NEC и многие другие.
В 1950 г. фирма GSI разработала первый кремниевый транзистор, а с 1954 г., преобразившись в Texas Instruments , начала его серийное производство.
«Холодная война» и ее влияние на электронику
После окончания Второй мировой войны мир раскололся на два враждебных лагеря. В 1950-1953 гг. эта конфронтация вылилась в прямое военное столкновение – Корейскую войну. Фактически это была опосредованная война между США и СССР. В это же время США готовились к прямой войне с СССР. В 1949 г. в США был разработан опубликованный ныне план «Последний выстрел» (Operation Dropshot), фактически план Третье мировой войны, войны термоядерной. План предусматривал прямое нападение на СССР 1 января 1957 г . В течение месяца предполагалось сбросить на наши головы 300 50-килотонных атомных и 200 000 обычных бомб. Для этого план предусматривал разработку специальных баллистических ракет, подводных атомных лодок, авианосцев и многого другого. Так началась развязанная США беспрецедентная гонка вооружений, продолжавшаяся всю вторую половину прошлого века, продолжающаяся, не столь демонстративно, и сейчас.
В этих условиях перед нашей страной, выдержавшей беспрецедентную в моральном и экономическом отношении четырехлетнюю войну и добившейся победы ценой огромных усилий и жертв, возникли новые гигантские проблемы по обеспечению собственной и союзников безопасности. Пришлось срочно, отрывая ресурсы от измученного войной и голодного народа, создавать новейшие виды оружия, содержать в постоянной боеготовности огромную армию. Так были созданы атомные и водородные бомбы, межконтинентальные ракеты, система противоракетной обороны и многое другое. Наши успехи в области обеспечения обороноспособности страны и реальная возможность получения сокрушительного ответного удара вынудили США отказаться от реализации плана «Dropshot» и других ему подобных.
Одним из последствий «холодной войны» была почти полная экономическая и информационная изоляция противостоящих сторон. Экономические и научные связи были весьма слабы, а в области стратегически важных отраслей и новых технологий практически отсутствовали. Важные открытия, изобретения, новые разработки в любой области знаний, которые могли быть использованы в военной технике или способствовать экономическому развитию, засекречивались. Поставки прогрессивных технологий, оборудования, продукции запрещались. В результате советская полупроводниковая наука и промышленность, развивались в условиях почти полной изоляции, фактической блокады от всего того, что делалось в этой области в США, Западной Европе, а затем и Японии.
Важные открытия, изобретения, новые разработки в любой области знаний, которые могли быть использованы в военной технике или способствовать экономическому развитию, засекречивались. Поставки прогрессивных технологий, оборудования, продукции запрещались. В результате советская полупроводниковая наука и промышленность, развивались в условиях почти полной изоляции, фактической блокады от всего того, что делалось в этой области в США, Западной Европе, а затем и Японии.
Следует также отметить, что советская наука и промышленность во многих направлениях тогда занимала лидирующее в мире положение. Наши истребители в корейской войне были лучше американских, наши ракеты были мощнее всех, в космосе в те годы мы были впереди планеты всей, первый в мире компьютер с производительностью выше 1 млн. оп/с был наш, водородную бомбу мы сделали раньше США, баллистическую ракету первой сбила наша система ПРО и т.п. Отстать в электронике означало потянуть назад все остальные отрасли науки и техники.
Значение полупроводниковой техники в СССР понимали прекрасно, но пути и методы ее развития были иными, чем в США. Руководство страны сознавало, что противостояние в холодной войне можно обеспечить путем развития оборонных систем, управляемых надежной, малогабаритной электроникой. В 1959 году были основаны такие заводы полупроводниковых приборов, как Александровский, Брянский, Воронежский, Рижский и др. В январе 1961 г. было принято Постановление ЦК КПСС и СМ СССР «О развитии полупроводниковой промышленности», в котором предусматривалось строительство заводов и НИИ в Киеве, Минске, Ереване, Нальчике и других городах. Причем базой для создания первых предприятий полупроводниковой промышленности стали совершенно не приспособленные для этих целей помещения (здания коммерческого техникума в Риге, Совпартшколы в Новгороде, макаронная фабрика в Брянске, швейная фабрика в Воронеже, ателье в Запорожье и т.д.). Но вернемся к истокам.
Первые советские транзисторы
В годы, предшествующие изобретению транзистора, в СССР были достигнуты значительные успехи в создании германиевых и кремниевых детекторов. В этих работах использовалась оригинальная методика исследования приконтактной области путем введения в нее дополнительной иглы, вследствие чего создавалась конфигурация, в точности повторяющая точечный транзистор. Иногда при измерениях выявлялись и транзисторные характеристики (влияние одного «p n» перехода на другой близко расположенный), но их отбрасывали как случайные и неинтересные аномалии. Мало в чем наши исследователи уступали американским специалистам, не было у них лишь одного нацеленности на транзистор, и великое открытие выскользнуло из рук. Начиная с 1947 г. интенсивные работы в области полупроводниковых усилителей велись в ЦНИИ-108 (лаб. С. Г. Калашникова) и в НИИ-160 (НИИ «Исток», Фрязино, лаб. А. В. Красилова). В 1948 г., группа А. В. Красилова, разрабатывавшая германиевые диоды для радиолокационный станций, также получила транзисторный эффект и попыталась объяснить его. Об этом в журнале «Вестник информации» в декабре 1948 ими была опубликована статья «Кристаллический триод» первая публикация в СССР о транзисторах.
В этих работах использовалась оригинальная методика исследования приконтактной области путем введения в нее дополнительной иглы, вследствие чего создавалась конфигурация, в точности повторяющая точечный транзистор. Иногда при измерениях выявлялись и транзисторные характеристики (влияние одного «p n» перехода на другой близко расположенный), но их отбрасывали как случайные и неинтересные аномалии. Мало в чем наши исследователи уступали американским специалистам, не было у них лишь одного нацеленности на транзистор, и великое открытие выскользнуло из рук. Начиная с 1947 г. интенсивные работы в области полупроводниковых усилителей велись в ЦНИИ-108 (лаб. С. Г. Калашникова) и в НИИ-160 (НИИ «Исток», Фрязино, лаб. А. В. Красилова). В 1948 г., группа А. В. Красилова, разрабатывавшая германиевые диоды для радиолокационный станций, также получила транзисторный эффект и попыталась объяснить его. Об этом в журнале «Вестник информации» в декабре 1948 ими была опубликована статья «Кристаллический триод» первая публикация в СССР о транзисторах.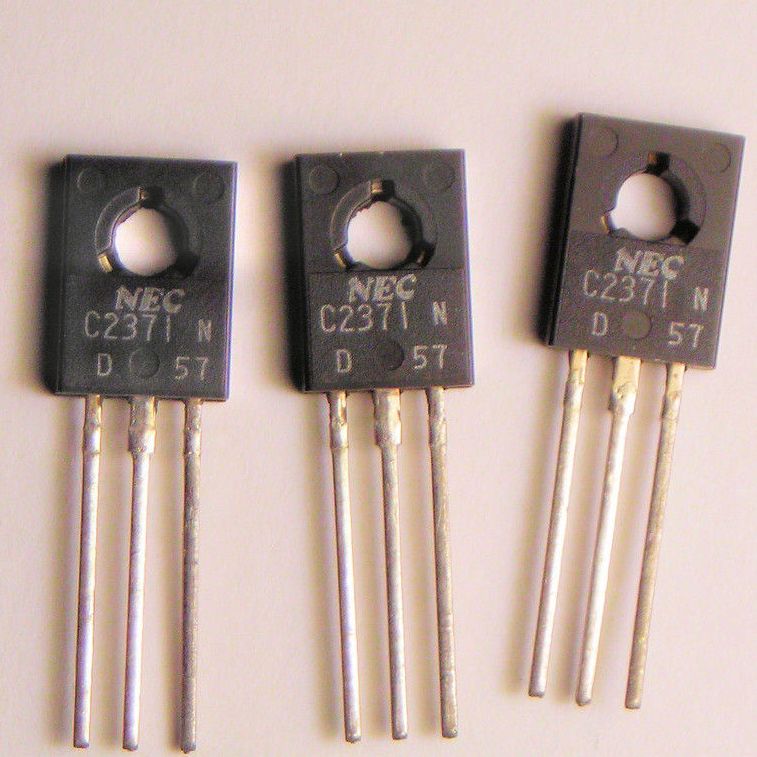 Напомним, что первая публикация о транзисторе в США в журнале «The Physical Review» состоялась в июле 1948 г., т.е. результаты работ группы Красилова были независимы и почти одновременны. Таким образом научная и экспериментальная база в СССР была подготовлена к созданию полупроводникового триода (термин «транзистор» был введен в русский язык в середине 60-х годов) и уже в 1949 г. лабораторией А. В. Красилова были разработаны и переданы в серийное производство первые советские точечные германиевые триоды С1 С4. В 1950 г. образцы германиевых триодов были разработаны в ФИАНе (Б.М. Вул, А. В. Ржанов, В. С. Вавилов и др.), в ЛФТИ (В.М. Тучкевич, Д. Н. Наследов) и в ИРЭ АН СССР (С.Г. Калашников, Н. А. Пенин и др.).
Напомним, что первая публикация о транзисторе в США в журнале «The Physical Review» состоялась в июле 1948 г., т.е. результаты работ группы Красилова были независимы и почти одновременны. Таким образом научная и экспериментальная база в СССР была подготовлена к созданию полупроводникового триода (термин «транзистор» был введен в русский язык в середине 60-х годов) и уже в 1949 г. лабораторией А. В. Красилова были разработаны и переданы в серийное производство первые советские точечные германиевые триоды С1 С4. В 1950 г. образцы германиевых триодов были разработаны в ФИАНе (Б.М. Вул, А. В. Ржанов, В. С. Вавилов и др.), в ЛФТИ (В.М. Тучкевич, Д. Н. Наследов) и в ИРЭ АН СССР (С.Г. Калашников, Н. А. Пенин и др.).
Первый советские промышленные транзистор:
точечный С1Г (слева) и плоскостный П1А (справа)
В мае 1953 г. был образован специализированный НИИ (НИИ-35, позже – НИИ «Пульсар»), учрежден Межведомственный Совет по полупроводникам. В 1955 г. началось промышленное производство транзисторов на заводе «Светлана» в Ленинграде, а при заводе создано ОКБ по разработке полупроводниковых приборов. В 1956 г. московский НИИ-311 с опытным заводом переименован в НИИ «Сапфир» с заводом «Оптрон» и переориентирован на разработку полупроводниковых диодов и тиристоров.
В 1956 г. московский НИИ-311 с опытным заводом переименован в НИИ «Сапфир» с заводом «Оптрон» и переориентирован на разработку полупроводниковых диодов и тиристоров.
На протяжении 50-х годов в стране были разработаны ряд новых технологий изготовления плоскостных транзисторов: сплавная, сплавно-диффузионная, меза-диффузионная.
Полупроводниковая промышленность СССР развивалась достаточно быстро: в 1955 г. было выпущено 96 тысяч, в 1957 г. – 2,7 млн, а в 1966 г. – более 11 млн. транзисторов. И это было только начало.
Статья помещена в музей 6.01.2008
На главную страницу || Карта сайта
| ||||||||
От составителя:В справочник по мощным транзисторам вошла как документация из
изданных еще при СССР каталогов, так и информация из справочных
листков и документация с сайтов производителей. Основой является таблица, где приведено наименование транзистора, аналоги, тип проводимости, тип корпуса, максимально допустимые ток и напряжения и коэффициент усиления,
то есть основные параметры, по которым выбирается транзистор.
Руководствуясь этой таблицей, можно значительно сузить область поиска.
Всего в справочнике приведено подробное описание более 140 отечественных мощных транзисторов и более 100 их импортных аналогов.  | ||||||||
| Фильтр параметров: n-p-n p-n-p Составные транзисторы Высоковольтные Показать все | ||||||||
| Типы корпусов | ||||||||
| Наименование | Аналог | Корпус | Тип | Imax, A | Umax, В | h31e max | ||
| КТ501(А-Е) | BC212 | TO-18 | pnp | 0,3 | 30 | 240 | КТ501 предназначен для применения в усилителях низкой частоты. Справочные данные транзистора КТ501 содержатся в даташит. | |
| КТ502(А-Е) | MPSA56 | TO-92 | | pnp | 0,15 | 90 | 240 | Транзистор КТ502(А-Е) в корпусе ТО-92, предназначен для применения в усилителях низкой частоты.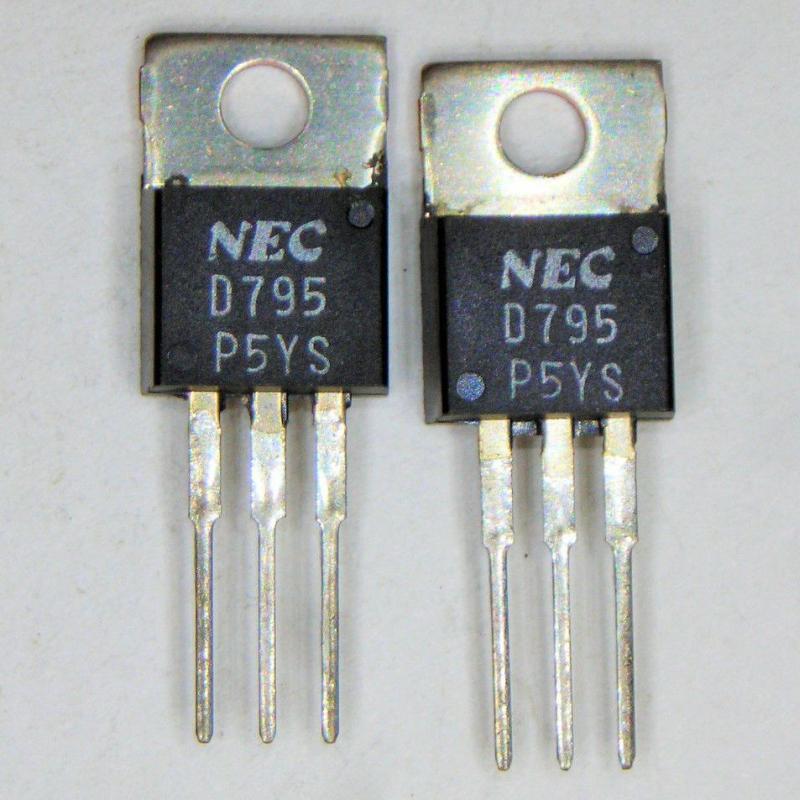 Подробные параметры КТ502 и цоколевка приведены в даташит. Аналог КТ502 —
MPSA56.
Комплементарная пара КТ503. Подробные параметры КТ502 и цоколевка приведены в даташит. Аналог КТ502 —
MPSA56.
Комплементарная пара КТ503. |
| КТ503(А-Е) | 2SC2240 | TO-92 | | npn | 0,15 | 100 | 240 | Универсальный транзистор КТ503(А-Е) в корпусе TO-92, предназначен для работы в усилителях НЧ. Подробные характеристики, графики зависимостей параметров и цоколевка КТ503 приведены в datasheet. Аналог КТ503 — 2SC2240. Комплементарная пара (транзистор обратной проводимости с близкими параметрами) — КТ502. |
| КТ504(А,Б,В) | BSS73 | TO-39 | npn | 1 | 350 | 100 | КТ504(А-В) в металлическом корпусе, для применения в преобразователях. Цоколевка и характеристики КТ504 содержатся в datasheet. Импортный аналог КТ504 — BSS73. | |
| KТ505(А,Б) | BSS76 | TO-39 | pnp | 1 | 300 | 100 | КТ505(А,Б) в металлическом корпусе предназначен для применения в источниках вторичного электропитания (ИВЭП). Параметры и
характеристики
приведены в справочном листке. Параметры и
характеристики
приведены в справочном листке. | |
| КТ506(А,Б) | BUX54 | TO-39 | npn | 2 | 800 | 30 | КТ506А и КТ506Б для переключающих устройств. Импортным аналогом КТ506 является BUX54. | |
| 2Т509А | TO-39 | pnp | 0,02 | 450 | 60 | 2Т509 для высоковольтных стабилизаторов напряжения. | ||
| КТ520(А,Б) | MPSA42 | TO-92 DPAK | npn | 0.5 | 300 | 40 | Высоковольтный транзистор КТ520 используется в выходных каскадах видеоусилителей и высоковольтных переключательных схемах. | |
| КТ521(А,Б) | MPSA92 | TO-92 | pnp | 0.5 | 300 | 40 | Высоковольтный транзистор КТ521 является комплиментарной парой для КТ520. | |
| КТ529А | TO-92 | pnp | 1 | 60 | 250 | КТ529,
его параметры
рассчитаны под схемы с низким напряжением насыщения. Комплементарная пара — КТ530. Комплементарная пара — КТ530. | ||
| КТ530А | TO-92 | npn | 1 | 60 | 250 | Описание транзистора КТ530. Его характеристики аналогичны КТ529, является его комплементарной парой. | ||
| КТ538А | MJE13001 | TO-92 | npn | 0.5 | 600 | 90 | Высоковольтный КТ538 используется в высоковольтных переключательных схемах. Подробно параметры описаны в справочном листке. | |
| КТ704(А-В) | MJE18002 | npn | 2,5 | 500 | 100 | КТ704, предназначен для применения в импульсных высоковольтных модуляторах. | ||
| ГТ705(А-Д) | npn | 3,5 | 30 | 250 | ГТ705 предназначен для применения в усилителях мощности НЧ. | |||
| 2Т708(А-В) | 2SB678 | TO-39 | pnp | 2,5 | 100 | 1500 | составной транзистор 2Т708 предназначен для применения в усилителях и переключательных устройствах. | |
| 2Т709(А-В) | BDX86 | TO-3 | pnp | 10 | 100 | 2000 | мощный составной транзистор 2Т709 для усилителей и переключательных устройств. Подробно характеристики описаны в справочном листке. | |
| КТ710А | TO-3 | npn | 5 | 3000 | 40 | КТ710А для применения в высоковольтных стабилизаторах и переключающих устройствах. | ||
| КТ712(А,Б) | BU806 | TO-220 | pnp | 10 | 200 | 1000 | мощные составные транзисторы КТ712А и КТ712Б. Характеристики заточены для применения в источниках вторичного электропитания и стабилизаторах. | |
| 2Т713А | TO-3 | npn | 3 | 2500 | 20 | 2Т713, параметры адаптированы для применения в высоковольтных стабилизаторах | ||
| 2Т716 (А-В) | 2SD472H | TO-3 | npn | 10 | 100 | 750 | 2Т716 для применения в усилителях и переключающих устройствах. | |
| 2Т716 (А1-В1) | BDX33 | TO-220 | npn | 10 | 100 | 750 | составной 2Т716А1 в пластиковом корпусе. Параметры аналогичны 2Т716. | |
| КТ719А | BD139 | TO-126 | npn | 1,5 | 120 | 70 | КТ719А для применения в линейных и переключающих схемах. Подробные характеристики и описание КТ719 приведено в справочном листке. | |
| КТ720А | BD140 | pnp | 1,5 | 100 | ||||
| КТ721А | BD237 | npn | 1,5 | 100 | BD237, импортный аналог КТ721А | |||
| КТ722А | BD238 | pnp | 1,5 | 100 | Справочные данные BD238, аналога КТ722А | |||
| КТ723А | MJE15028 | npn | 10 | 100 | Справочные данные MJE15028, импортного аналога КТ723 | |||
| КТ724А | MJE15029 | pnp | 10 | 100 | Справочные данные MJE15029, аналога КТ724А | |||
| КТ729 | 2N3771 | npn | 30 | 60 | Параметры 2N3771, аналога КТ729 | |||
| КТ730 | 2N3773 | npn | 16 | 140 | Характеристики 2N3773, аналога КТ730 | |||
| КТ732А | MJE4343 | TO-218 | npn | 16 | 160 | 15 | КТ732 используется в преобразователях напряжения. | |
| КТ733А | MJE4353 | TO-218 | pnp | 16 | 160 | 15 | КТ733 — Комплементарная пара для КТ732, их характеристики идентичны. | |
| КТ738А | TIP3055 | TO-218 | npn | 15 | 70 | 70 | КТ738 используется в усилителях и ключевых схемах. | |
| КТ739А | TIP2955 | TO-218 | pnp | 15 | 70 | 70 | КТ739 — Комплементарная пара для КТ738. | |
| КТ740А,А1 | MJE4343 | TO-220 TO-218 | npn | 20 | 160 | 30 | КТ740 предназначен для применения в регуляторах и преобразователях напряжения. Импортный аналог КТ740 — MJE4343 | |
| КТ805(А-ВМ) | KSD363 BD243 | TO-220 | | npn | 5 | 160 | 15 | КТ805АМ, КТ805БМ, КТ805ВМ в корпусе ТО-220 предназначен для применения в выходных каскадах строчной развертки и переключающих устройствах. Подробные характеристики транзистора КТ805 приведены в datasheet. Транзисторы
КТ805А, КТ805Б с аналогичными параметрами выпускаются в металлостеклянном корпусе. Импортные аналоги для КТ805 — транзисторы BD243 и KSD363. По характеристикам в качестве комплиментарной пары для КТ805 подходит транзистор КТ837. Подробные характеристики транзистора КТ805 приведены в datasheet. Транзисторы
КТ805А, КТ805Б с аналогичными параметрами выпускаются в металлостеклянном корпусе. Импортные аналоги для КТ805 — транзисторы BD243 и KSD363. По характеристикам в качестве комплиментарной пары для КТ805 подходит транзистор КТ837. |
| КТ807(А-БМ) | npn | 0,5 | 100 | 150 | КТ807 для строчной и кадровой разверток, усилителей НЧ и ИВЭП (ИВЭП — источник вторичного электропитания) | |||
| КТ808(А-ГМ) | TO-3 | npn | 10 | 130 | 50 | КТ808 для кадровой и строчной разверток | ||
| КТ812(А-В) | TO-3 | npn | 10 | 700 | 30 | КТ812 для применения в импульсных устройствах. Цоколевка приведена в справочном листке. | ||
| КТ814(А-Г) | BD140 ZTX753 | TO-126 DPAK | | pnp | 1,5 | 100 | 100 | Транзистор КТ814. предназначен для усилителей НЧ, импульсных устройств. Подробные характеристики КТ814 и цоколевка приведены в datasheet. Там же
графики: входной характеристики, зависимости h31e от тока эмиттера, напряжения насыщения от тока коллектора и другие. Импортный аналог КТ814 — транзистор BD140. Комплементарная предназначен для усилителей НЧ, импульсных устройств. Подробные характеристики КТ814 и цоколевка приведены в datasheet. Там же
графики: входной характеристики, зависимости h31e от тока эмиттера, напряжения насыщения от тока коллектора и другие. Импортный аналог КТ814 — транзистор BD140. Комплементарнаяпара для КТ814 (транзистор обратной проводимости с близкими характеристиками) — КТ815. |
| КТ815(А-Г) | BD139 ZTX653 | TO-126 DPAK | | npn | 1,5 | 100 | 100 | КТ815 является комплиментарной
парой для КТ814. Транзисторы КТ815А, КТ815Б, КТ815В, КТ815 параметрами отличаются по напряжению. КТ815 предназначен для усилителей НЧ и ключевых схем. Подробные характеристики
КТ815 и цоколевку см. в datasheet. Приведена входная характеристика КТ815, график зависимости h31e от тока, график для напряжения насыщения. Импортным аналогом КТ815 является транзистор BD139. Импортным аналогом КТ815 является транзистор BD139. |
| КТ816(А-Г) | BD238 MJE172 | TO-126 DPAK | | pnp | 3 | 80 | 100 | КТ816 в два раза мощнее по току, чем КТ814, предназначены для применения в ключевых и линейных схемах. Транзисторы КТ816А, КТ816Б, КТ816В, КТ816Г отличаются по предельному напряжению. Подробные характеристики КТ816 и цоколевка приведены в datasheet. Там же график входной характеристики КТ816, зависимости усиления от тока, графики для напряжения насыщения. Импортным аналогом КТ816 является транзистор BD238. Комплементарная пара — КТ817. |
| КТ817(А-Г) | BD237 MJE182 | TO-126 DPAK | | npn | 3 | 80 | 100 | КТ817 в два раза мощнее по току, чем КТ815. Применяются в ключевых и линейных схемах. Транзисторы КТ817А, КТ817Б, КТ817В, КТ817
параметрами отличаются по Uкэ(max). Подробные характеристики
КТ817 и цоколевка даны в datasheet. Кроме характеристик по постоянному току приведены графики входной характеристики, зависимости параметра h31e от тока, взаимосвязи параметров Uкэнас и Iк . Аналоги КТ817Б — транзисторы BD233 и MJE180. Аналоги КТ817В — BD235 и MJE181, импортные аналоги КТ817Г — BD237 и MJE182. Комплементарная пара — КТ816. Подробные характеристики
КТ817 и цоколевка даны в datasheet. Кроме характеристик по постоянному току приведены графики входной характеристики, зависимости параметра h31e от тока, взаимосвязи параметров Uкэнас и Iк . Аналоги КТ817Б — транзисторы BD233 и MJE180. Аналоги КТ817В — BD235 и MJE181, импортные аналоги КТ817Г — BD237 и MJE182. Комплементарная пара — КТ816. |
| КТ818(А-ГМ) | BDW22 BD912 | TO-220 TO-3 | | pnp | 10 15 | 100 | 100 | Мощный транзистор КТ818 предназначен для применения в усилителях. КТ818А, КТ818Б, КТ818В и КТ818Г в корпусе TO-220, а КТ818АМ, КТ818БМ, КТ818ВМ и КТ818ГМ в металлическом корпусе. Подробные характеристики
КТ818 и цоколевка приведены в datasheet. Там же графики зависимостей
параметров, входная и выходная характеристика. Импортные аналоги КТ818 — BDW22 и BD912. |
| КТ819(А-ГМ) | BDW51 BD911 | TO-220 TO-3 | | npn | 10 15 | 100 | 100 | Транзистор КТ819 является комплементарной парой для КТ818 и предназначен для применения в усилителях. Транзисторы КТ819А, КТ819Б, КТ819В и КТ819Г в корпусе TO-220, а КТ819АМ, КТ819БМ, КТ819ВМ и КТ819ГМ в корпусе TO-3. Подробные параметры КТ819 и цоколевка приведены в datasheet. Там же графики зависимостей, входная и выходная характеристика. Импортные аналоги КТ819 — BDW51 и BD911. |
| КТ825(Г-Е) | 2Т6050 | TO-220 TO-3 | pnp | 15 20 | 100 | 18000 | Мощный составной pnp транзистор КТ825 для применения в усилителях и переключающих устройствах. 2Т825А, 2Т825Б, 2Т825В, КТ825Г, КТ825Д и КТ825Е в металлическом корпусе. Подробные характеристики приведены в datasheet. Различие в параметрах по напряжению.
Комплементарная пара для КТ825 — транзистор КТ827. Импортный аналог — 2T6050. Различие в параметрах по напряжению.
Комплементарная пара для КТ825 — транзистор КТ827. Импортный аналог — 2T6050. | |
| КТ826(А-В) | TO-3 | npn | 1 | 700 | 120 | Биполярный транзистор КТ826 для применения в преобразователях и высоковольтных стабилизаторах. Описание КТ826 и характеристики приведены в документации. | ||
| КТ827(А-В) | 2N6057 BDX87 | TO-3 | npn | 20 | 100 | 18000 | Мощный составной npn транзистор КТ827 для применения в усилителях, стабилизаторах тока, устройствах автоматики. В металлическом корпусе. Подробные характеристики КТ827А, КТ827Б, КТ827В приведены в даташит. Различаются параметрами по напряжению. Комплементарная пара для КТ827 — транзистор КТ825. Импортный аналог — 2N6057. | |
| КТ828(А-Г) | BU207 | TO-3 | npn | 5 | 800 | 15 | характеристики
КТ828, графики и параметры см. в даташит в даташит | |
| КТ829(А-Г) | TIP122 2N6045 | TO-220 | npn | 8 | 100 | 3000 | Составной транзистор КТ829 для применения в усилителях НЧ и переключательных устройствах. Графики входных характеристик. Подробные характеристики транзисторов КТ829А, КТ829Б, КТ829В,КТ829Г в datasheet . Аналоги КТ829 — транзисторы TIP122 и 2N6045. | |
| 2Т830(А-Г) | 2N5781 | TO-39 | pnp | 2 | 90 | 160 | транзистор 2Т830 для применения в усилителях мощности и ИВЭП. Аналог 2Т830 — 2N5781. | |
| 2Т831(А-В) | 2N4300 | TO-39 | npn | 2 | 50 | 200 | 2Т831 для усилителей НЧ и преобразователей. | |
| КТ834(А-В) | BU323 | TO-3 | npn | 15 | 500 | 3000 | составной транзистор
КТ834 для источников тока и напряжения. | |
| КТ835(А,Б) | 2N6111 | TO-220 | pnp | 7,5 | 30 | 100 | транзистор КТ835 для усилителей и преобразователей. Аналог КТ835 — импортный 2N6111 | |
| 2Т836(А-В) | BD180 | TO-39 | pnp | 3 | 90 | 100 | 2Т836 для усилителей мощности и ИВЭП. | |
| КТ837(А-Ф) | 2N6108 2N6111 | TO-220 | | pnp | 8 | 70 | 200 | pnp транзистор КТ837 предназначен для применения в усилителях и переключающих устройствах. Корпус пластмассовый TO-220. Подробные параметры КТ837А, КТ837Б, КТ837В, КТ837Г, КТ837Д, КТ837Е-Ф указаны в файле. Аналог для КТ837 — транзистор 2N6108 с близкими характеристиками. |
| КТ838А | 2SD1554 BU208 | TO-3 | npn | 5 | 1500 | 14 | Высоковольтный транзистор КТ838А для строчной развертки телевизоров . Характеристики
КТ838А приведены в файле. Импортные аналоги — 2SD1554 и BU208. Характеристики
КТ838А приведены в файле. Импортные аналоги — 2SD1554 и BU208. | |
| КТ839А | 2SC1172 MJ16212 | TO-3 | npn | 10 | 1500 | 12 | Характеристики и параметры КТ839 аналогичны транзистору КТ838, но круче по току. | |
| КТ840(А,Б) | BUX97 | TO-3 | npn | 6 | 400 | 100 | Биполярный транзисторы КТ840А и КТ840Б для применения в переключающих устройствах. Подробные параметры приведены в файле. | |
| КТ841(А-В) | MJ413 2N3442 | TO-3 | npn | 10 | 600 | 35 | Мощный биполярный транзистор КТ841 для применения в мощных преобразователях. Подробные параметры транзисторов КТ841А, КТ841Б, КТ841В в даташит. | |
| КТ842(А,Б) | 2SB506 | TO-3 | pnp | 5 | 300 | 30 | Биполярный транзистор
КТ842 для применения в мощных преобразователях и линейных стабилизаторах напряжения.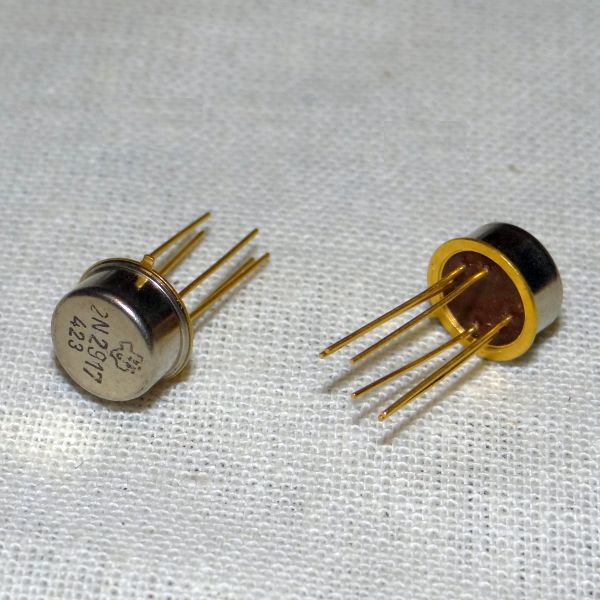 | |
| КТ844А | MJ15011 | TO-3 | npn | 10 | 250 | 60 | КТ844 предназначен для импульсных устройств, подробное описание приведено в datasheet | |
| КТ845А | TO-3 | npn | 5 | 400 | 100 | КТ845А разработан для применения в импульсных устройствах. | ||
| КТ846А | BU208 | TO-3 | | npn | 5 | 1500 | 15 | Высоковольтный биполярный транзистор КТ846А, входные характеристики, графики приведены в datasheet. |
| КТ847А | BUX48 2N6678 | TO-3 | npn | 15 | 650 | 100 | Подробное описание КТ847А, входные и выходные характеристики. Аналогом для КТ847 является BUX48. | |
| КТ848А | BUX37 | TO-3 | npn | 15 | 400 | 1000 | Составной транзистор КТ848А для систем электронного зажигания. Характеристики
КТ848 в прикрепленном файле. Аналог КТ848 — BUX37. Характеристики
КТ848 в прикрепленном файле. Аналог КТ848 — BUX37. | |
| КТ850(А-В) | 2SD401 | TO-220 | npn | 2 | 250 | 200 | КТ850 заточен для применения в усилителях мощности и переключающих устройствах. Подробное описание КТ850А, КТ850Б, КТ850В и графики приведены в datasheet . | |
| КТ851(А-В) | 2SB546 | TO-220 | pnp | 2 | 200 | 200 | КТ851 для усилителей НЧ и переключающих устройств. Параметры КТ851А, КТ851Б, КТ851В см. в файле pdf | |
| КТ852(А-Г) | TIP117 | TO-220 | pnp | 2 | 100 | 1500 | Составной КТ852 для усилителей и переключающих устройств. Параметры КТ852А в даташит. | |
| КТ853(А-Г) | TIP127 2N6042 | TO-220 | pnp | 8 | 100 | 750 | Составной pnp транзистор
КТ853. Предназначен для применения в усилительных схемах. Параметры КТ853А, КТ853Б, КТ853В, КТ853Г см. в pdf файле. Предназначен для применения в усилительных схемах. Параметры КТ853А, КТ853Б, КТ853В, КТ853Г см. в pdf файле. | |
| КТ854(А,Б) | MJE13006 | TO-220 | npn | 10 | 500 | 50 | КТ854 для применения в преобразователях и линейных стабилизаторах. Справочные данные приведены в datasheet. | |
| КТ855(А-В) | MJE9780 | TO-220 | pnp | 5 | 250 | 100 | КТ855 для применения в преобразователях, линейных стабилизаторах. Аналог с близкими характеристиками — MJE9780. | |
| 2Т856(А-В) | BUX48 | TO-3 | npn | 10 | 950 | 60 | 2Т856 для переключательных устройств. Аналог — BUX48. | |
| КТ856(А1,Б1) | BUV48 | TO-218 | npn | 10 | 600 | 60 | КТ856 для применения в усилителях и переключающих устройствах. Справочные данные КТ856А1, КТ856Б1 см. в datasheet . Справочные данные КТ856А1, КТ856Б1 см. в datasheet . | |
| КТ857А | BU408 | TO-220 | npn | 7 | 250 | 50 | КТ857 для применения в усилителях и переключающих устройствах. Аналог — BU408. | |
| КТ858А | BU406 | TO-220 | npn | 7 | 400 | 60 | транзистор КТ858 предназначен для применения в переключающих устройствах. Аналог — BU406. Подробное описание смотри в datasheet . | |
| КТ859А | MJE13005 | TO-220 | npn | 3 | 800 | 60 | Высоковольтный КТ859 заточен для переключающих устройств. Параметры и цоколевка КТ859 приведены в datasheet. Импортный аналог с близкими характеристиками — MJE13005. | |
| 2Т860(А-В) | TO-39 | pnp | 2 | 90 | 100 | 2Т860 предназначен для усилителей мощности и преобразователей. | ||
| 2Т862(А-Г) | TO-3 | npn | 15 | 400 | 100 | 2Т862 для применения в импульсных модуляторах и переключающих устройствах. | ||
| КТ863Б,В | D44Vh20 | TO-220 | npn | 10 | 160 | 300 | Транзистор КТ863 предназначен для применения в преобразователях, фотовспышках. Справочные характеристики см. в datasheet. Аналог КТ863 — D44Vh20. | |
| КТ863БС | D44Vh20 | TO-220 TO-263 | npn | 12 | 160 | 300 | КТ863БС — более свежая разработка. Модификация КТ863БС1 предназначена для поверхностного монтажа. | |
| КТ864А | 2N3442 | TO-3 | npn | 10 | 200 | 100 | КТ864 для применения в ИВЭП, усилителях и стабилизаторах. | |
| КТ865А | 2SA1073 | TO-3 | pnp | 10 | 200 | 60 | Область применения
транзистора КТ865 та же, что и у КТ864. | |
| КТ867А | TIP35 | TO-3 | npn | 25 | 200 | 100 | КТ867 для применения в ИВЭП. В описании транзистора приведены графики зависимости коэффициента усиления от тока и график области максимальных режимов. | |
| КТ868(А,Б) | BU426 | pnp | 6 | 400 | 60 | КТ868 предназначен для применения в источниках питания телевизоров. Подробные характеристики см. в datasheet. Функциональный аналог КТ868 — BU426. | ||
| КТ872(А-В) | BU508 MJW16212 | TO-218 | | npn | 8 | 700 | 16 | Высоковольтный npn транзистор КТ872 для применения в строчной развертке телевизоров. Подробное описание КТ872 приведено в справочном листе. Аналоги КТ872 — транзисторы BU508 и MJV16212. |
| 2Т875(А-Г) | 2SD1940 | TO-3 | npn | 10 | 90 | 200 | 2Т875 для применения в усилителях и переключающих устройствах. | |
| 2Т876(А-Г) | MJE2955 | TO-3 | pnp | 10 | 90 | 140 | 2Т876 для применения в усилителях и переключающих устройствах. | |
| 2Т877(А-В) | 2N6285 | TO-3 | pnp | 20 | 80 | 10000 | Составной транзистор 2Т877 для применения в усилителях и переключающих устройствах. | |
| КТ878(А-В) | BUX98 | TO-3 | npn | 30 | 900 | 50 | КТ878 для применения в переключающих устройствах, ИВЭП. | |
| КТ879 | npn | 50 | 200 | 25 | КТ879 для применения в переключающих устройствах. | |||
| 2Т880(А-В) | 2N6730 | pnp | 2 | 100 | 140 | 2Т880 — для усилителей и переключательных устройств. | ||
| 2Т881(А-Г) | 2N5150 | npn | 2 | 100 | 200 | 2Т881 — применение аналогично 2Т880 | ||
| 2Т882(А-В) | TO-220 | npn | 1 | 300 | 100 | 2Т882 в корпусе ТО-220 для применения в усилителях и переключающих устройствах. Цоколевка и характеристики приведены в pdf. | ||
| 2Т883(А,Б) | TO-220 | pnp | 1 | 300 | 100 | 2Т883 для усилителей и переключающих устройств. Корпус ТО-220. | ||
| 2Т884(А,Б) | TO-220 | npn | 2 | 800 | 40 | 2Т884 для применения в усилителях и переключающих устройствах. Подробные параметры см. в datasheet . | ||
| 2Т885(А,Б) | TO-3 | npn | 40 | 500 | 12 | мощный транзистор
2Т885 предназначен для применения в ИВЭП. | ||
| КТ886(А1,Б1) | MJW16212 | TO-218 | npn | 10 | 1400 | 25 | Высоковольтный транзистор КТ886 для применения в строчной развертке и ИВЭП. Характеристики см. в файле pdf. Аналог для КТ886 — MJW16212. | |
| КТ887 А,Б | TO-3 | pnp | 2 | 700 | 120 | КТ887 для переключательных схем, стабилизаторов напряжения. | ||
| КТ888 А,Б | TO-39 | pnp | 0,1 | 900 | 120 | Высоковольтный транзистор КТ888 для применения в преобразователях и стабилизаторах напряжения ИВЭП. | ||
| КТ890(А-В) | BU323 | TO-218 | npn | 20 | 350 | 700 | Составной транзистор
КТ890 предназначен для применения в схемах зажигания авто. Подробные характеристики КТ890А, КТ890Б и КТ890В приведены в pdf. Аналогом для КТ890 является
BU323. Аналогом для КТ890 является
BU323. | |
| КТ892(А-В) | BU323A | TO-3 | npn | 15 | 400 | 300 | мощный транзистор КТ892 предназначен для применения в схемах зажигания авто и других схемах с индуктивной нагрузкой. | |
| КТ896 (А,Б) | BDW84 | TO-218 | pnp | 20 | 80 | 10000 | Составной мощный транзистор КТ896 для применения в линейных и переключающих схемах. Характеристики КТ896А и КТ896Б см. в datasheet файле. Аналог для КТ896 — BDW84. | |
| КТ897(А,Б) | BU931Z | TO-3 | npn | 20 | 350 | 4000 | Составной транзистор КТ897 для схем зажигания авто и других схем с индуктивной нагрузкой. Аналог для КТ897 — BU931. | |
| КТ898 (А,Б) | BU931P | TO-218 | npn | 20 | 350 | 1500 | Составной транзистор
КТ898 для применения в ИВЭП. Параметры оптимизированы для работы на индуктивную нагрузку. Аналог КТ898 — BU931. Подробные характеристики КТ898А и КТ898Б см. в datasheet. Параметры оптимизированы для работы на индуктивную нагрузку. Аналог КТ898 — BU931. Подробные характеристики КТ898А и КТ898Б см. в datasheet. | |
| КТ899А | BU806 | TO-220 | npn | 8 | 150 | 1000 | Составной транзистор КТ899 для применения в усилительных и переключательных устройствах. Аналог с близкими характеристиками — BU806. | |
| КТ8101(А,Б) | MJE4343 2SC3281 | TO-218 | npn | 16 | 200 | 100 | мощный транзистор КТ8101 предназначен для применения в усилителях НЧ, стабилизаторах и преобразователях. Подробные характеристики КТ8101А и КТ8101Б см. в datasheet. Аналог для КТ8101 — транзистор MJE4343. Комплементарная пара — КТ8102. | |
| КТ8102(А,Б) | MJE4353 2SA1302 | TO-218 | | pnp | 16 | 200 | 100 | Мощный транзистор КТ8102, область применения аналогична КТ8101, являющемуся его комплиментарной парой. Характеристики
КТ8102А, КТ8102Б приведены в datasheet . Импортный аналог для КТ8102 — MJE4353. Характеристики
КТ8102А, КТ8102Б приведены в datasheet . Импортный аналог для КТ8102 — MJE4353. |
| КТ8106 (А,Б) | MJH6286 | TO-218 | npn | 20 | 80 | 3000 | Составной транзистор КТ8106 для применения в усилителях мощности и переключающих схемах. Аналог для КТ8106 — MJH6286. | |
| КТ8107(А-В) | BU208 | TO-218 | npn | 8 | 700 | 12 | КТ8107 для применения в каскадах строчной развертки, ИВЭП, высоковольтных схемах. Подробные параметры в datasheet. Импортный аналог для КТ8107 — BU208. | |
| КТ8109 | TIP151 | TO-220 | npn | 7 | 350 | 150 | Составной транзистор КТ8109 для схем зажигания авто. Справочные данные см. в datasheet. | |
| КТ8110 (А-В) | BUT11 | npn | 7 | 400 | 30 | Справочные данные BUT11, импортного аналога
КТ8110. | ||
| КТ8111(А9-Б9) | BDV67 | TO-218 | npn | 20 | 100 | 750 | Составной мощный транзистор КТ8111 для применения в усилителях НЧ, стабилизаторах тока и напряжения, переключателях. Аналог — BDV67. | |
| КТ8115(А-В) | BD650 TIP127 | TO-220 | pnp | 8 5 | 100 | 1000 | Составной pnp транзистор
КТ8115А для применения в усилительных и преобразователях напряжения. Аналог для
КТ8115 — BD650. Комплементарная пара — КТ8116. | |
| КТ8116(А-В) | TIP132 | TO-220 DPAK | | npn | 8 5 | 100 | 1000 | Составной транзистор КТ8116, область применения аналогична КТ8115, являющимся его комплементарной парой. |
| КТ8117А | BUV48 | TO-218 | npn | 10 | 400 | 10 | мощный транзистор
КТ8117 предназначен для ИВЭП, управления двигателями, стабилизаторов тока. | |
| КТ8118А | MJE8503 | TO-220 | npn | 3 | 800 | 40 | КТ8118 для высоковольтных переключательных схем, усилителей постоянного тока. | |
| КТ8120А | TO-220 | npn | 8 | 450 | 10 | КТ8120 для ИВЭП, схем управления электродвигателями. | ||
| КТ8121А,Б | TO-220 | npn | 4 | 400 | 60 | КТ8121 для высоковольтных переключающих схем, преобразователей | ||
| КТ8123А | TO-220 | npn | 2 | 150 | 40 | КТ8123 для схем вертикальной развертки ТВ, усилителей. | ||
| КТ8124(А-В) | TO-220 | npn | 10 | 400 | 7 | Справочные данные
КТ8124, предназначенного для применения в горизонтальной развертке ТВ, переключательных схемах. | ||
| КТ8126(А1,Б1) | MJE13007 | TO-220 | | npn | 8 | 400 | 30 | мощный транзистор КТ8126 для применения в горизонтальной развертке ТВ, преобразователях. Справочные данные приведены в datasheet . |
| КТ8130 (А-В) | BD676 | pnp | 4 | 80 | 15000 | |||
| КТ8131 (А,Б) | BD677 | npn | 4 | 80 | 15000 | |||
| КТ8133 (А,Б) | npn | 8 | 240 | 3000 | ||||
| КТ8137А | MJE13003 | TO-126 | npn | 1,5 | 700 | 40 | Для применения в строчной развертке ТВ, управления двигателями. | |
| КТ8141 (А-Г) | npn | 8 | 100 | 750 | ||||
| КТ8143 (А-Ш) | КТ-9М | npn | 80 | 300 | 15 | биполярный мощный высоковольтный n-p-n транзистор с диодом КТ8143 для низковольтных источников питания бортовой аппаратуры | ||
| КТ8144(А,Б) | TO-3 | npn | 25 | 800 | 55 | |||
| КТ8146(А,Б) КТ8154(А,Б) КТ8155(А-Г) | ТО-3 | | npn | 15 30 50 | 800 600 600 | мощный высоковольтный транзистор для применения в источниках питания | ||
| КТ8156(А,Б) | BU807 | TO-220 | npn | 8 | 200 | 1000 | КТ8156 предназначен для применения в горизонтальных развертках малогабаритных ЭЛТ. | |
| КТ8157(А-В) | TO-218 | npn | 15 | 1500 | 8 | для строчных разверток ТВ с увеличенной диагональю экрана | ||
| КТ8158(А-В) | BDV65 | TO-218 | npn | 12 | 100 | 1000 | КТ8158, параметры заточены для применения в усилителях НЧ, в ключевых и линейных схемах. | |
| КТ8159(А,Б,В) | BDV64 | TO-218 | pnp | 12 | 100 | 1000 | КТ8159, Комплементарная пара для КТ8158, параметры и область применения аналогичные. | |
| КТ8163А | npn | 7 | 500 | 40 | ||||
| КТ8164(А,Б) | MJE13005 | TO-220 | npn | 4 | 400 | 60 | Высоковольтный транзистор КТ8164 для импульсных источников питания. | |
| КТ8167 (А-Г) | pnp | 2 | 80 | 250 | ||||
| КТ8168 (А-Г) | npn | 2 | 80 | 250 | ||||
| КТ8170(А1,Б1) | MJE13003 | TO-126 | npn | 1.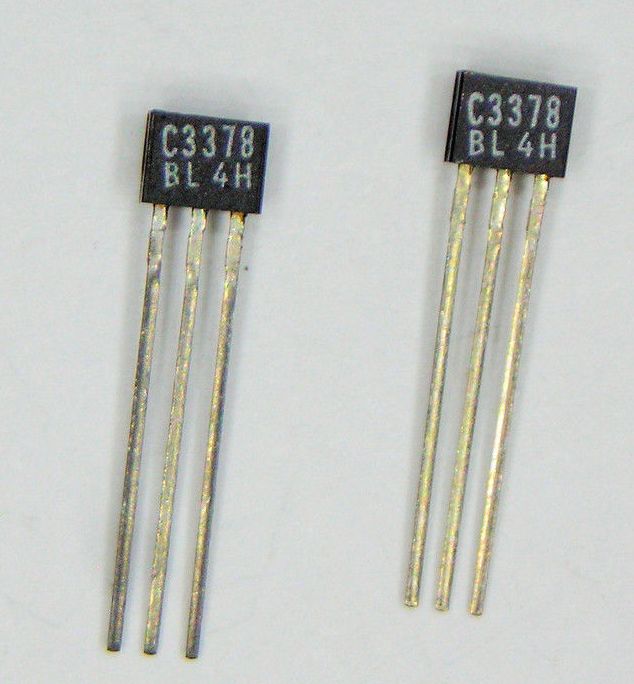 5 5 | 400 | 40 | Высоковольтный транзистор КТ8170 для применения в импульсных источниках питания. | |
| КТ8171 (А,Б) | npn | 20 | 350 | 10000 | ||||
| КТ8176(А,Б,В) | TIP31 | TO-220 | npn | 3 | 100 | 50 | КТ8176 для усилителей и переключательных схем. | |
| КТ8177(А,Б,В) | TIP32 | TO-220 | pnp | 3 | 100 | 50 | КТ8177 для усилителей и переключательных схем. Комплементарная пара для КТ8176. | |
| КТ8192 (А-В) | ISOTOP | npn | 75 | 1500 | 10 | мощный npn транзистор КТ8192 для применения в электроприводе | ||
| КТ8196 (А-В) | npn | 10 | 350 | 400 | ||||
| КТ8212(А,Б,В) | TIP41 | TO-220 | npn | 6 | 100 | 75 | КТ8212 для линейных и ключевых схем.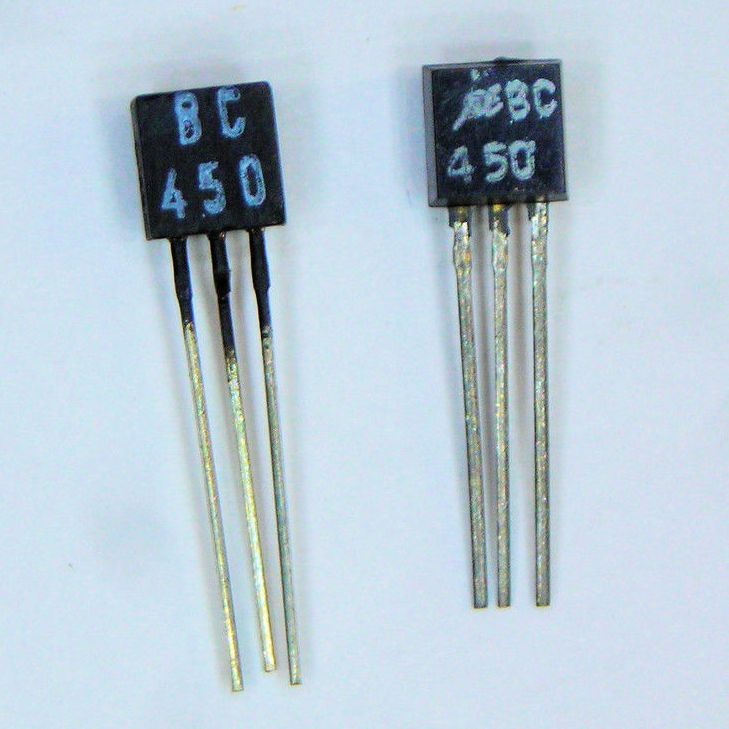 | |
| КТ8213(А,Б,В) | TIP42 | TO-220 | pnp | 6 | 100 | 75 | Комплементарная пара для КТ8212. | |
| КТ8214(А,Б,В) | TIP112 | TO-220 | npn | 2 | 100 | 1000 | Составной транзистор КТ8214 предназначен для применения в ключевых и линейных схемах. | |
| КТ8215(А,Б,В) | TIP117 | TO-220 | pnp | 2 | 100 | 1000 | Составной транзистор КТ8215 — Комплементарная пара КТ8214. | |
| КТ8216 (А-Г) | MJD31B | npn | 2 | 800 | 275 | |||
| КТ8217 (А-Г) | MJD32B | pnp | 10 | 100 | 275 | |||
| КТ8218 (А-Г) | npn | 4 | 100 | 750 | ||||
| КТ8219 (А-Г) | pnp | 4 | 40 | 750 | ||||
| КТ8224(А,Б) | BU2508 | TO-218 | npn | 8 | 700 | 7 | Высоковольтный транзистор КТ8224 для применения в высоковольтных схемах ТВ приемников. Аналог — BU2508. Интегральный демпфирующий диод и резистор база-эмиттер. Аналог — BU2508. Интегральный демпфирующий диод и резистор база-эмиттер. | |
| КТ8228(А,Б) | BU2525 | TO-218 | npn | 12 | 800 | 10 | Высоковольтный транзистор КТ8228 для применения в высоковольтных схемах ТВ приемников. Белорусский аналог BU2525. Диод между коллектором э эмиттером, резистор между базой-эмиттером. | |
| КТ8229А | TIP35F | TO-218 | npn | 25 | 180 | 75 | КТ8229 для линейных и ключевых схем. | |
| КТ8230А | TIP36F | TO-218 | pnp | 25 | 180 | 75 | КТ8230 -Комплементарная пара для КТ8229. | |
| КТ8231А | BU941 | npn | 15 | 500 | 300 | datasheet на транзистор BU941 | ||
| КТ8232 (А,Б) | BU941ZP | TO-218 | npn | 20 | 350 | 300 | КТ8232 для применения в переключательных и импульсных схемах, параметры оптимизированы для схем зажигания. | |
| КТ8246(А-Г) | КТ829 | TO-220 | npn | 15 | 150 | 9000 | Составной транзистор КТ8246 для применения в автотракторных регуляторах напряжения. | |
| КТ8247А | BUL45D | TO-220 | npn | 5 | 700 | 22 | Высоковольтный транзистор КТ8247 для применения в преобразователях напряжения. Аналог — BUL45. Интегральный демпфирующий диод и резистор база-эмиттер. | |
| КТ8248А | BU2506 | TO-218 | npn | 5 | 1500 | 60 | Высоковольтный транзистор КТ8247 для применения в строчных развертках ТВ. Аналог — BU2506. Интегральный демпфирующий диод и резистор база-эмиттер. | |
| КТ8251А | BDV65 | TO-218 | npn | 10 | 180 | 1000 | Составной npn транзистор КТ8251 для применения в линейных усилителях и ключевых преобразователях напряжения.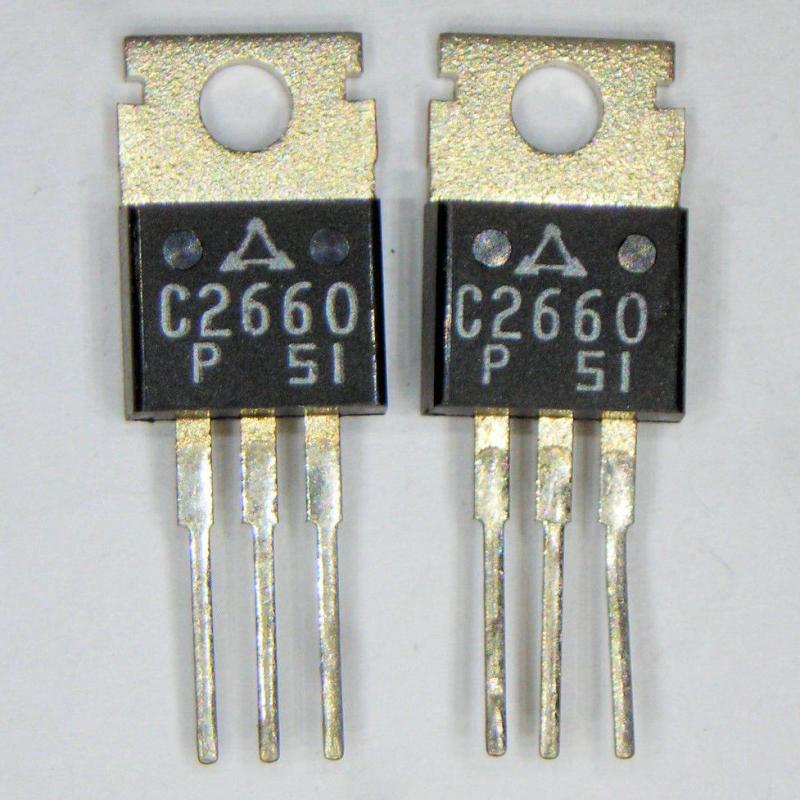 | |
| КТД8252(А-Г) | BU323Z | TO-220 TO-218 | npn | 15 | 350 | 2000 | для работы на индуктивную нагрузку | |
| КТ8254А | npn | 2 | 800 | 30 | ||||
| КТ8255А | BU407 | TO-220 | npn | 7 | 330 | 200 | КТ8255 для применения линейных и ключевых схемах. | |
| КТД8257(А-В) | SGSD96 | TO-220 | npn | 20 | 180 | 1000 | для применения в усилителях НЧ и переключающих устройствах. | |
| КТ8258(А,Б) | MJE 13004 | TO-220 | npn | 4 | 400 | 80 | для использования в преобразователях, в линейных и ключевых схемах, аналог транзистора 13004 | |
| КТ8259(А,Б) | MJE13007 13007 | TO-220 | npn | 8 | 400 | 80 | для использования в преобразователях, в линейных и ключевых схемах, отечественный аналог импортного транзистора 13007 | |
| КТ8260(А-В) | MJE13008 | TO-220 | npn | 15 | 500 | 15 | для ИВЭП, преобразователей, аналог транзистора 13008. | |
| КТ8261А | BUL44 | TO-126 | npn | 2 | 400 | 20 | КТ8261 для применения в преобразователях напряжения. | |
| КТД8262(А-В) | SEC80 | TO-220 | npn | 7 | 350 | 300 | Для систем зажигания автотракторной техники | |
| КТ8270А | MJE13001 | TO-126 | npn | 0.5 | 600 | 90 | КТ8270 для использования в преобразователях напряжения. Подробные справочные данные приведены в datasheet. | |
| КТ8271(А,Б,В) | BD136 | TO-126 | pnp | 1.5 | 80 | 250 | КТ8271 для преобразователей напряжения. Подробные параметры приведены в datasheet. | |
| КТ8272(А,Б,В) | BD135 | TO-126 | npn | 1.5 | 80 | 250 | КТ8272 для линейных усилителей и преобразователей напряжения.
Комплементарная пара для КТ8271 | |
| КТД8278(А-В1) | SGSD93ST | TO-220 | npn | 20 | 180 | 1000 | Для усилителей НЧ, переключательных устройств. | |
| КТД8279(А-В) | 2SD1071 | TO-220 TO-218 | npn | 10 | 350 | 300 | для работы на индуктивную нагрузку, в системах зажигания. | |
| КТД8280(А-В) | TO-218 | npn | 60 | 120 | 1000 | Составной транзистор КТД8280 для преобразователей напряжения, схем управления двигателями, источников бесперебойного питания. | ||
| КТД8281(А-В) | TO-218 | pnp | 60 | 120 | 1000 | Составной транзистор КТД8281 для преобразователей напряжения, схем управления двигателями. | ||
| КТ8283(А-В) | TO-218 | pnp | 60 | 120 | 100 | для преобразователей, схем управления двигателями. Параметры описаны в даташит. | ||
| КТ8284(А-В) | КТ829 | TO-220 | npn | 12 | 100 | 500 | для автотракторных регуляторов напряжения, линейных схем. | |
| КТ8285(А-В) | BUF410 | TO-218 TO-3 | npn | 30 | 450 | 40 | для преобразователей напряжения, ИВЭП. Характеристики описаны в даташит. | |
| КТ8286(А-В) | 2SC1413 | TO-218 TO-3 | npn | 5 | 800 | 40 | для усилителей низкой частоты, переключающих устройствах, мощных регуляторах напряжения. Подробные характеристики см. в datasheet | |
| КТ8290А | BUh200 | TO-220 | npn | 10 | 700 | 15 | Высоковольтный биполярный транзистор КТ8290 для использования в импульсных источниках питания. | |
| КТ8296(А-Г) | KSD882 | TO-126 | npn | 3 | 30 | 400 | КТ8296 для использования в импульсных источниках питания, ключевых схемах и линейных усилителях. | |
| КТ8297(А-Г) | KSD772 | TO-126 | pnp | 3 | 30 | 400 | КТ8297 —
Комплементарная пара (транзистор с близкими характеристиками, но обратной проводимости) для КТ8296. | |
| КТ8304А,Б | TO-220 D2PAK | npn | 8 | 160 | 250 | КТ8304 с демпферным диодом для автомобильных регуляторов напряжения. | ||
| ПИЛОН-3 | TIP122 | TO-220 | npn | 15 | 100 | 1000 | для применения в переключающих схемах и преобразователях напряжения. Импортный аналог с близкими характеристиками — транзистор TIP122. | |
| ПИР-1 | BUV48 | TO-218 | npn | 20 | 450 | 8 | ПИР-1 для ключевых схем с индуктивной нагрузкой и усилителей с высокой линейностью. | |
| ПИР-2 | MJE4343 | TO-220 TO-218 | npn | 20 | 160 | 30 | ПИР-2 для линейных усилителей и ключевых схем. | |
| Справочник составлен в 2007 году, затем дополнялся и дорабатывался вплоть до 2015г. Соавторы: WWW и Ко | ||||||||
bjt на Alibaba
Примечание. Некоторые элементы запрещены к отображению / продаже на нашем веб-сайте в соответствии с Политикой листинга продуктов. Например, такие лекарства, как аспирин.
0,1-10 долл. США / шт. (цена FOB)
100 шт. (мин. Заказ)
0,1-0,3 долл. США / шт. (цена FOB)
10 шт. (мин. Заказ)
0 долларов США.04-0,65 / шт. (цена FOB)
1 шт. (минимальный заказ)
US $ 0,01-1 / шт. (цена FOB)
1 шт. (минимальный заказ)
42,0-43,0 долл. США / шт. (цена FOB)
1 шт. (минимальный заказ)
0,02–1 / долл. США (цена FOB)
1 шт. ( Мин. Заказ)
US $ 0.2-2 / шт. (цена FOB)
1 шт. (минимальный заказ)
0,014–0,018 долл. США / шт. (цена FOB)
10 шт. (минимальный заказ)
0,1–1 /
долларов США 5 штук (цена FOB)
1 штука (минимальный заказ)
0,05–0,2 долларов США / штук (цена FOB)
1 штука ( Мин. Заказ)
US $ 0.1-0,9 / шт. (цена FOB)
20 штук (минимальный заказ)
US $ 0,08-0,1 / штук (цена FOB)
100 штук (минимальный заказ)
0,03–0,03 долл. США / шт. (цена FOB)
1 шт. (минимальный заказ)
0,01–2 / долл. США (цена FOB)
1 шт. ( Мин. Заказ)
US $ 0.03-0.03 / шт. (цена FOB)
1 шт. (минимальный заказ)
0,1-10,0 долл. США / шт. (цена FOB)
1 шт. (минимальный заказ)
0,03–0,03 долл. США / шт. (цена FOB)
1 шт. (минимальный заказ)
0,03–0,03 долл. США / шт. (цена FOB)
1 шт. ( Мин. Заказ)
1 доллар США.2-1,2 / Пара (цена FOB)
2 пары (минимальный заказ)
US $ 0,05-0,07 / шт. (цена FOB)
10 штук (минимальный заказ)
0,32-0,35 долл. США / шт. (цена FOB)
10 шт. (минимальный заказ)
0,5–3 долл. США / шт. (цена FOB)
5 шт. Мин. Заказ)
US $ 0.21-0,25 / штук (цена FOB)
1000 штук (минимальный заказ)
US $ 0,01-0,5 / штук (цена FOB)
1 штука (минимальный заказ)
0,13–0,16 долл. США / шт. (цена FOB)
100 шт. (минимальный заказ)
0,01–0,5 долл. США / шт. (цена FOB)
(1 шт.
) Мин.Заказ)
0,13–0,16 долл. США / шт. (цена FOB)
100 шт. (минимальный заказ)
0,0058–0,0162 долл. США / шт. (цена FOB)
шт. (Мин. Заказ)
2-4 /
US $ 5 шт. (Цена FOB)
10 шт. (Мин. Заказ)
0,88-2,88 $ / US $ (FOB Цена)
1000 штук (мин.Заказ)
0,01–1 /
US $ 5 шт. (цена FOB)
1 шт. (минимальный заказ)
US $ 0,5–0,8 / шт. (цена FOB)
10 шт. (Мин. Заказ)
0,5–1,5 долл. США / шт. (цена FOB)
1 шт. (минимальный заказ)
1,29–1,29 долл. США / Сумка (цена FOB)
1 мешок (мин.Заказ)
0,06-0,1 долл. США / шт. (цена FOB)
10 шт. (минимальный заказ)
0,1-10 / долл. США (цена FOB)
10 шт. (Мин. Заказ)
0,01–1 / US $ Шт. (Цена FOB)
10 Шт. (Мин. Заказ)
{{#if priceFrom}}{{priceCurrencyType}} {{priceFrom}} {{#if priceTo}} — {{priceTo}} {{/если}} {{#if priceUnit}} / {{priceUnit}} {{/если}}
{{/если}} {{#if minOrderQuantity}}{{minOrderQuantity}} {{#if minOrderType}} {{minOrderType}} {{/если}}
{{/если}} Фототранзистор— обзор | Темы ScienceDirect
Оптический датчик положения коленчатого вала
В достаточно чистой окружающей среде положение вала также можно определить с помощью оптических методов.Рисунок 6.17 иллюстрирует такую систему. Опять же, как и в случае с магнитной системой, диск напрямую соединен с коленчатым валом. На этот раз в диске есть отверстия, соответствующие количеству выступов на дисках магнитных систем. С каждой стороны диска смонтированы оптоволоконные световоды. Отверстие в диске позволяет передавать свет через световоды от источника светодиода (LED) к фототранзистору, используемому в качестве светового датчика. Свет не будет передаваться от источника к датчику, когда нет отверстия, потому что твердый диск блокирует свет.С другой стороны, всякий раз, когда отверстие в диске совмещается с одной из оптоволоконных световодов, свет от светодиода проходит через диск на фототранзистор.
Рисунок 6.17. Оптический датчик углового положения.
Светоизлучающий диод, используемый в качестве источника света для этого датчика, находит все большее количество других применений в автомобильных системах, включая освещение (например, стоп-сигналы, указатели поворота и приборные дисплеи). Теория работы светодиода объясняется в главе 9.Светодиоды изготавливаются из различных полупроводниковых материалов и доступны в диапазоне длин волн от инфракрасного до ультрафиолетового, в зависимости от материала, изготовления и напряжения возбуждения. Есть даже сейчас светодиод белого света.
Другой важный компонент оптического датчика положения, показанного на рис. 6.17a, — это фототранзистор. Биполярный фототранзистор по существу имеет конфигурацию обычного транзистора, имеющего области коллектора, базы и эмиттера. Однако вместо того, чтобы вводить неосновные носители в базовую область через электрический источник (т.е.е., через базовый ток i b ) полученный свет выполняет эту функцию. Фототранзистор сконструирован таким образом, что свет от источника фокусируется на область перехода. Ширина запрещенной зоны базовой области Δ E g (т. Е. Щель в допустимой энергии электронов от верха валентной зоны до нижнего края зоны проводимости — см. Главу 3) определяет длину волны света, до которой фототранзистор отвечает.
На рисунке 6.17b изображен фототранзистор NPN и его схема заземленного эмиттера.Переход коллектор – база имеет обратное смещение. Входящий свет с уровнем освещенности P фокусируется линзой на основание (b) фототранзистора. Когда фотоны входящего света поглощаются в области базы, они создают носители заряда, эквивалентные току базы обычного биполярного транзистора. Как объяснялось в главе 3, увеличение носителей в базовой области приводит к увеличению тока коллектор-эмиттер. Следовательно, ток коллектора I c изменяется линейно с P и определяется как
(48) Ic = Io + βγP
, где β = усиление тока заземленного эмиттера
= постоянная преобразования силы света в эквивалентный базовый ток.
Напряжение нагрузки В L равно
(49) VL = Vcc − IcRL = Vcc − RL (Io + βγP)
Каждый раз, когда отверстие в диске проходит через оптоволоконный свет В тракте, показанном на рис. 6.17a, напряжение нагрузки будет представлять собой импульс высокого и низкого напряжения. Усилитель может быть сконфигурирован с отрицательным усилением напряжения, так что на его выходе будет положительный импульс напряжения в момент, когда любое отверстие проходит оптический путь. Эти импульсы напряжения можно использовать для определения углового положения вращающегося вала (например,g., коленчатый вал) аналогично магнитным датчикам положения, описанным выше.
Одна из проблем оптических датчиков заключается в том, что они должны быть защищены от грязи и масла; в противном случае оптический путь будет иметь недопустимую пропускную способность. С другой стороны, у них есть преимущества, заключающиеся в том, что они могут определять положение без работающего двигателя и что амплитуда импульсов практически постоянна при изменении скорости.
PNP PIN-биполярные фототранзисторы для высокоскоростных приложений, построенные по технологии 180 нм CMOS
Solid State Electron.2012 Авг; 74 (5): 49–57.
Институт электродинамики, СВЧ и схемотехники, Венский технологический университет, Gusshausstr. 25/354, 1040 Вена, Австрия
Эта статья цитируется в других статьях в PMC.Особенности
► Показаны три оптимизированных по скорости фототранзистора pnp, построенных по технологии 180 нм CMOS. ► Между базой и коллектором был реализован толстый низколегированный внутренний слой. ► Толстая область пространственного заряда база – коллектор приводит к высокой пропускной способности.► Оптические характеристики были выполнены при 410 нм, 675 нм и 850 нм. ► Достигнуты полосы пропускания до 76,9 МГц и динамическая чувствительность до 2,89 А / Вт.
Ключевые слова: PNP, PIN, интегрированный фототранзистор, световой детектор, кремний, фотодетектор
Abstract
В этой работе описываются трехскоростные оптимизированные биполярные фототранзисторы pnp, построенные в стандартном процессе 180 нм CMOS с использованием специальной стартовой пластины. Исходная пластина состоит из низколегированного эпитаксиального слоя p поверх p-подложки.Этот эпитаксиальный слой с низким содержанием примесей p приводит к образованию толстой области пространственного заряда между базой и коллектором и, таким образом, к высокой полосе пропускания -3 дБ при низких напряжениях коллектор-эмиттер. Для дальнейшего увеличения полосы пропускания представленные фототранзисторы были разработаны с небольшими площадями эмиттера, что привело к небольшой емкости база-эмиттер. Три представленных фототранзистора были выполнены в размерах 40 × 40 мкм 2 и 100 × 100 мкм 2 . Оптические измерения постоянного и переменного тока на длине волны 410 нм, 675 нм и 850 нм были выполнены для определения характеристик фототранзистора.Благодаря оптимизированной по быстродействию конструкции и слоистой структуре фототранзисторов была достигнута полоса пропускания до 76,9 МГц и динамическая чувствительность до 2,89 A / Вт. Кроме того, было выполнено моделирование напряженности электрического поля и областей пространственного заряда.
1. Введение
Фотодиоды и фототранзисторы являются наиболее часто используемыми фотодетекторами. Обеспечивая дополнительное усиление, фототранзисторы более подходят для некоторых приложений, чем фотодиоды, например, в условиях низкой освещенности.В настоящее время фотодетекторы встраиваются в кремниевые технологии (это также могут быть стандартные процессы CMOS или BiCMOS) или как составные устройства III – V. Фотодетекторы, интегрированные в стандартные процессы на основе кремния, имеют ряд преимуществ по сравнению с фотодетекторами, реализованными в специальных кремниевых или композитных технологиях III-V. Основным преимуществом реализации стандартного кремниевого процесса является возможность дешевого массового производства детектора и схемы вместе. Возможность комбинировать фотодетектор вместе со схемой считывания с оптоэлектронными интегральными схемами (OEIC) дает дополнительные преимущества интегральных решений по сравнению с решениями с проводным соединением из-за отсутствия контактных площадок и соединительных проводов, что снижает паразитность [1].
Физические свойства кремния позволяют материалу быть чувствительным к длинам волн от 300 до 1100 нм. Свет в этом диапазоне длин волн проникает в кремний и поглощается им. В зависимости от длины волны света каждый фотон может создавать одну или несколько электронно-дырочных пар. Фотон может создать более одной пары электрон-дырка, только если это фотон высокой энергии (соответствует длинам волн ниже 375 нм) [2,3]. Однако фотон также может поглощаться свободными носителями без образования электронно-дырочной пары (поглощение свободными носителями) [4].Тем не менее, если кремниевые фотоприемники используются в видимом и ближнем инфракрасном диапазоне (400–900 нм), как показывает литература, обоими упомянутыми эффектами можно пренебречь. Следовательно, для диапазона видимого света скорость генерации G электронно-дырочных пар в кремнии можно упростить до [1]:
G ( x , λ ) = Φ 0 α ( λ ) e — α ( λ ) x
(1)
Скорость генерации G зависит от глубины x от поверхности полупроводника, от длины волны λ , от потока фотонов Φ 0 падающего света и от коэффициента поглощения α .Коэффициент поглощения α сильно уменьшается с увеличением длины волны λ . Приведем два соответствующих примера: синий свет (например, 430 нм) поглощается на глубине до 0,2 мкм, в то время как ближний инфракрасный свет (например, 850 нм) имеет глубину проникновения 1/ e около 16,6 мкм [1]. В смещенном фотоприемнике электрическое поле разделяет носители. Глубина проникновения, зависящая от длины волны, приводит к зависящему от длины волны распределению общего фототока на дрейфовую и диффузионную части, что дополнительно приводит к зависящим от длины волны полосам пропускания и чувствительности.
Фотодиоды — самые распространенные фотоприемники. Они могут быть реализованы как устройство pn-перехода или штифтовое соединение. Разница между обеими структурами заключается в дополнительном низколегированном слое в штыревом фотодиоде. В области перехода фотодиода образуется область пространственного заряда. Область пространственного заряда штыревого фотодиода толще из-за наличия дополнительного низколегированного слоя между анодом и катодом. Для вертикального штыревого фотодиода это приведет к более высокой чувствительности к более глубокому проникающему свету и, как правило, к более высокой полосе пропускания, поскольку часть тока дрейфа увеличивается.PN-фотодиоды могут быть построены тремя различными способами в стандартном процессе CMOS с использованием p-подложки: n-лунка / p-подложка, n + / p-подложка и p + / n-лунка. Эти диоды характеризуются тонкой областью пространственного заряда и, следовательно, небольшим дрейфовым фототоком, что приводит к относительно небольшой полосе пропускания из-за большого вклада диффузионного тока от фотозарядов, генерируемых ниже области пространственного заряда. Однако при добавлении толстого внутреннего слоя между анодом и катодом фотодиода образуется толстая область пространственного заряда и, таким образом, также толстая зона дрейфа.Более толстая зона дрейфа приводит к большей доле дрейфового тока по сравнению с диффузионным током, что, кроме того, приводит к более широкой полосе пропускания для низких напряжений смещения. Преимущество более широкой полосы пропускания в pin-фотодиодах по сравнению с pn-фотодиодами делает их наиболее часто используемыми детекторами для высокоскоростных оптических приложений, например, в оптических приемниках [5]. Такой вертикальный штыревой фотодиод с полосой пропускания -3 дБ, равной 2,8 ГГц, при В D = 20 В и 0,2 А / Вт для чувствительности 850 нм представлен в [6].Другой вертикальный штыревой фотодиод с чувствительностью 0,135 A / Вт для 850 нм и полосой пропускания 1,6 ГГц при В D = 15,5 В представлен в [7]. Более того, штыревые фотодиоды также могут быть реализованы как боковые устройства. В [7] представлены боковые штыревые фотодиоды с чувствительностью до 0,15 А / Вт для 850 нм и полосой пропускания до 3,1 ГГц при В D = 15,5 В. Для сравнения, pn-фотодиоды, представленные в [8], достигают полосы пропускания 80 МГц при В D = 8 В и чувствительности 0.215 A / W и 0,15 A / W для 650 нм. Как видно из представленных значений, фотодиоды могут обеспечивать лишь небольшую чувствительность в диапазоне 600–800 нм. Это связано с максимальной квантовой эффективностью η = 1. Однако максимальная квантовая эффективность не может быть достигнута в реальных устройствах из-за отражения света от поверхности, а также рекомбинации фотогенерированных зарядов в кремнии.
Фотоприемники с собственным усилением тока представлены лавинными фотодиодами и фототранзисторами.Благодаря собственному усилению тока эти фоточувствительные устройства могут улучшить ограничение квантовой эффективности фотодиодов и достичь значений η больше, чем 1.
Лавинные фотодиоды достигают своего собственного усиления тока за счет процесса лавинного умножения. Недостатком этого процесса является то, что для достижения достаточной напряженности электрического поля для собственного усиления тока требуются напряжения в диапазоне нескольких десятков вольт [9]. Высокое напряжение является проблемой для интегральных схем и даже более серьезной проблемой для современных низковольтных процессов.Однако новые типы лавинных фотодиодов, так называемые SPAD (однофотонные лавинные фотодиоды), могут работать при меньших напряжениях, чем стандартные лавинные фотодиоды. В [10] представлены два типа SPAD с пробивным напряжением 23,1 В и 16,1 В соответственно. Еще одним недостатком фотодетекторов такого типа является очень узкий диапазон напряжения смещения для линейной работы APD и SPAD.
Фототранзисторы имеют большое преимущество перед ЛФД в том, что им не требуется высокое напряжение для собственного усиления тока.В BiCMOS сообщалось о достаточно быстрых вертикальных npn-фототранзисторах с чувствительностью 2.7 A / W на длине волны 850 нм (из-за тонкой области пространственного заряда база-коллектор) [11]. Другой SiGe-фототранзистор BiCMOS с чувствительностью 5,2 А / Вт на длине волны 850 нм представлен в [12]. В технологии CMOS могут быть построены различные типы фототранзисторов, например вертикальные биполярные фототранзисторы [13–18], боковые биполярные фототранзисторы [19], фото-MOSFET [20] и так далее. Вертикальные биполярные фототранзисторы с полосой пропускания до 14 МГц и чувствительностью до 98 А / Вт на длине волны 675 нм представлены в [13] и [14].Усилитель синхронизации CMOS, представленный в [15], использует фототранзисторы pnp с полосой пропускания в несколько сотен кГц. Ref. [16] описывает фототранзистор pnp с полосой пропускания 7,8 МГц на длине волны 638 нм. В [17] представлены фотодиод и фототранзистор npn в КМОП-процессе 65 нм. Фототранзистор обеспечивает чувствительность 0,34 A / Вт и полосу пропускания 150 кГц. В данной работе описаны расширенные результаты фототранзисторов, представленных в [18].
2. Принцип работы
Вертикальный фототранзистор pnp формируется в процессе CMOS путем реализации n-лунки (базы) в p-подложке (коллекторе) и ap + -источника / стока (эмиттера) в n -хорошо.a изображает поперечное сечение обычного биполярного фототранзистора pnp. Фототранзистор pnp может использоваться только в конфигурации эмиттер-повторитель, поскольку подложка образует коллектор. Фототранзистор можно описать как фотодиод (переход база-коллектор) и внутренний биполярный переходный транзистор для усиления тока. Длинноволновый свет проникает глубоко в кремний и генерирует большинство зарядов в области пространственного заряда база-коллектор. Здесь заряды разделяются, и электроны уносятся в основание, а дырки — в коллектор.Накопление электронов в базе делает потенциал базы более отрицательным, таким образом, напряжение прямого смещения диода база-эмиттер увеличивается, и инжекция дырок из эмиттера в базу становится сильнее. Большая часть инжектированных отверстий может диффундировать через тонкое основание и достигать области пространственного заряда база-коллектор на другом конце области базы. Этот процесс приводит к усилению первичного фототока. Собственное усиление тока β является соотношением между током коллектора I C и первичным фототоком I PH .Дополнительную литературу по обычным КМОП-фототранзисторам можно найти в [1,21,22].
Трехмерное изображение и поперечное сечение фототранзисторов: (a) общий фототранзистор pnp, интегрированный в технологию CMOS, фототранзисторы PIN PNP: (b) 50 B Center E , (c) 100 B Edge E и (d) 100 B Quad E .
3. Методология
Мы представляем три оптимизированных по скорости фототранзистора pnp PIN размером 40 × 40 мкм 2 и 100 × 100 мкм 2 .Фототранзисторы построены по технологии CMOS 180 нм без каких-либо модификаций процесса и были изготовлены LFoundry. Для достижения высокой пропускной способности использовалась специальная пластина. Эта пластина состоит из подложки p + с выращенным на ней низколегированным (5 × 10 13 см −3 ) p эпитаксиальным слоем толщиной 15 мкм. Поэтому даже при низких напряжениях из-за присутствующего низколегированного эпитаксиального p-слоя образуется толстая область объемного заряда база-коллектор. PIN-структура диода база-коллектор имеет те же свойства, что и упомянутые PIN-фотодиоды в разделе 1, и поэтому приводит к быстрому разделению фотогенерированных зарядов.Вследствие толстой области объемного заряда дрейфовая часть фототока для глубоко проникающего света увеличивается и, следовательно, приводит к более высокой чувствительности по сравнению с обычным биполярным фототранзистором, подобным представленному в [15].
Полоса пропускания и чувствительность фототранзисторов зависят также от свойств компоновки области базы и эмиттера. Уравнение (2) показывает взаимосвязь между полосой пропускания фототранзистора по уровню −3 дБ и физическими свойствами фототранзистора [21]:
f-3dB = 12πβ · τB + kBTqIE (CBE + CBC),
(2)
где f −3 дБ — полоса пропускания фототранзистора по −3 дБ, β — коэффициент усиления прямого тока фототранзистора, τ B — базовое время прохождения, k B — время прохождения Постоянная Больцмана, T — абсолютная температура, q — элементарный заряд, I E — ток эмиттера фототранзистора, C BE — емкость база-эмиттер и C BC — емкость база – коллектор.
Ширина полосы по уровню −3 дБ зависит от обеих емкостей области пространственного заряда C BE и C BC , усиления по току β , базового времени прохождения τ B и тока эмиттера I Е . В случае больших значений емкости ширина полосы по уровню –3 дБ в основном зависит от обеих емкостей области пространственного заряда: C BE и C BC . Для быстрых фототранзисторов желательно уменьшение этих емкостей.В представленных нами фототранзисторах емкость C BC мала по сравнению с обычными фототранзисторами (например, a) из-за реализованного толстого эпитаксиального p-слоя с низким уровнем легирования. Кроме того, уменьшение емкости C BE достигается за счет уменьшения площади эмиттера. Относительно базового легирования следует упомянуть два противоположных эффекта. С одной стороны, уменьшение концентрации легирования в базе может привести к увеличению полосы пропускания, поскольку обе области пространственного заряда будут проникать глубже в базу, что приведет к более широким областям пространственного заряда и, следовательно, к меньшим емкостям C BE и C BC .Как второе следствие большей области пространственного заряда, эффективная ширина базы W становится короче, что приводит к уменьшению базового времени прохождения τ B и, таким образом, также к увеличению полосы пропускания. С другой стороны, более толстые области пространственного заряда вызовут уменьшение напряженности электрического поля внутри областей пространственного заряда при тех же потенциальных условиях, что приведет к более медленному устройству, поскольку скорость носителей заряда в области пространственного заряда будет быть уменьшенным. Это видно из моделирования в разделе 5.1. Кроме того, уменьшение базовой концентрации легирования приводит к более высокому усилению собственного тока β и, следовательно, к более высокому току коллектора и эмиттера I C и I E . Более высокий ток эмиттера вызовет согласно формуле. (2) более высокая пропускная способность. Отсюда следует, что для фототранзисторов с обычно небольшими емкостями перехода (например, оптимизированная схема эмиттера, структура PIN) частотное поведение устройства становится более зависимым от других параметров, таких как β , τ B и I E .Дальнейшее увеличение полосы пропускания может быть достигнуто за счет уменьшения существующей емкости по периметру и, кроме того, за счет уменьшения размера всего фототранзистора. Уменьшение емкости по периметру было достигнуто путем добавления зазора 3 мкм с низким уровнем легирования между основанием с n-ямкой и контактом коллектора с p-ямкой. Однако полоса пропускания фототранзистора PIN ниже, чем полоса пропускания фотодиода PIN из-за обеих емкостей перехода и базового времени прохождения τ B , что не является проблемой для фотодиода.
Как упоминалось выше, полоса пропускания будет увеличиваться при уменьшении площади эмиттера. С другой стороны, меньшая площадь излучателя приводит к меньшей чувствительности, если освещается все устройство. Причина меньшей чувствительности — более высокая вероятность рекомбинации заряда из-за большего расстояния пробега. Заряды, которые не генерируются непосредственно под эмиттером, должны проходить большие расстояния через базу, чтобы достичь перехода база-эмиттер. Эти заряды будут вносить вклад в фототок, только если их время жизни больше, чем время, необходимое для достижения области пространственного заряда база-эмиттер.Что касается чувствительности, базовая концентрация легирования также играет решающую роль. Для меньшей концентрации легирования основы формируется более тонкая эффективная ширина W основы, что приводит к уменьшению расстояния прохождения генерируемых зарядов через основание. Это увеличивает вероятность того, что заряды достигнут перехода база-эмиттер, и, таким образом, также увеличивает собственное усиление тока β . Собственное усиление тока β пропорционально концентрации легирования эмиттера N E и числу Гаммеля N G , которое описывает концентрацию легирования N B основания [22]:
Как следствие, мы можем сказать, что для достижения высокой чувствительности фототранзисторы должны быть спроектированы с большим эмиттером по всей светочувствительной области вместе с низколегированной базой.Принимая во внимание, что для достижения более высокой полосы пропускания фототранзисторы должны быть спроектированы с очень маленькими эмиттерными площадями вместе со значительно более высокими легированными основаниями. Кроме того, следует отметить, что при уменьшении концентрации легирования в основе увеличивается вероятность сквозного контакта между коллектором и эмиттером, чего следует избегать. Однако представленные фототранзисторы предназначены для приложений с высокой пропускной способностью и поэтому выполнены с небольшими площадями эмиттера. В разделе, посвященном измерениям в этой статье, можно увидеть, что даже при высоких напряжениях коллектор-эмиттер нет сквозного прохода.
4. Реализованные фототранзисторы
Три реализованные версии фототранзисторов (b – d) были построены с размерами 40 × 40 мкм 2 и 100 × 100 мкм 2 и из-за разной компоновки базы и эмиттера имели разные характеристики:
- • 50 B Центр E : Этот фототранзистор был разработан с полосатым основанием. Эти n-луночные полоски имеют ширину 0,5 мкм и разделены зазорами шириной 0,5 мкм между собой. Во время изготовления полосы с n-ямками будут диффундировать из-за теплового баланса в один слой с половинной концентрацией легирования основы, состоящей из полной n-ямы.Это также причина, по которой это устройство называется 50 B Center E. Излучатель этого устройства имеет размер 0,74 × 0,74 мкм 2 и расположен в центре светочувствительной области.
- • 100 B Edge E : Как видно из названия, это устройство состоит из полноценного n-луночного основания и эмиттера на краю светочувствительной области. Он имеет немного большую площадь эмиттера по сравнению с фототранзистором 50 B Center E из-за требований правил проектирования.Область эмиттера имеет размер 2,18 × 0,32 мкм 2 и образована имплантатом истока / стока p + . Идея размещения эмиттера на краю светочувствительной области основана на идее реализации антиотражающего слоя и травления оптического окна поверх светочувствительной области и, таким образом, увеличения чувствительности устройства. Однако для лучшего сравнения использовались устройства без края оптического окна.
- • 100 B Quad E : Это устройство имеет такую же компоновку, как и предыдущее.Разница между обоими фототранзисторами заключается в том, что это устройство имеет четыре отдельные эмиттерные области. Каждая эмиттерная область расположена в центре каждого квадранта светочувствительной области. Все области эмиттера соединены металлическими линиями минимальной ширины поверх фототранзистора.
5. Результаты и обсуждение
Мы охарактеризовали представленные фототранзисторы с помощью оптических измерений постоянного и переменного тока. Оптические измерения постоянного тока проводились с использованием лазера с длиной волны 850 нм для определения выходной характеристики фототранзистора и его чувствительности по постоянному току.Также была измерена спектральная чувствительность по всему спектру видимого света. Измерения динамической чувствительности и полосы пропускания фототранзисторов проводились при 410 нм, 675 нм и 850 нм соответственно. Для определения характеристик фототранзисторов использовалось следующее оборудование: три упомянутых лазерных источника, монохроматор для измерения спектральной чувствительности, оптический аттенюатор и измеритель оптической мощности для контроля мощности света, источники-измерители-блоки (SMU) для подачи напряжения. и измерения тока, осциллографа для измерения чувствительности к переменному току и векторного анализатора цепей для измерения переходной характеристики частоты соответственно.Все оптические пути были откалиброваны с помощью оптического светодиода. Кроме того, моделировались напряженность электрического поля и области пространственного заряда фототранзисторов.
5.1. Моделирование напряженности электрического поля и области пространственного заряда
Моделирование напряженности электрического поля и области пространственного заряда было выполнено для того, чтобы прояснить различия между различными напряжениями коллектор-эмиттер В CE и различными концентрациями легирования основы.Фототранзистор 50 B Center E был смоделирован в условиях темного освещения при В CE = −2 В, −5 В и −10 В всегда с плавающей базой. изображает напряженность электрического поля в этом фототранзисторе. На этом рисунке заметны толстая дрейфовая зона области объемного заряда база – коллектор и напряженность электрического поля. Пики, близкие к Y = 0 мкм, связаны с контактами коллектора, базы и эмиттера фототранзистора. Для лучшего сравнения напряженности электрического поля в области объемного заряда база – коллектор для трех напряжений коллектор – эмиттер на графике была ограничена напряженность электрического поля.Пики сильной напряженности электрического поля в области контакта не показаны, чтобы улучшить масштабирование общей картины. Напряженность электрического поля в области объемного заряда база-эмиттер достигает 35 кВ / см. Границы областей пространственного заряда для фототранзистора 50 B Center E показаны на рис. Фототранзистор был смоделирован с одним слоем с n-ямками с половинной концентрацией легирования, поскольку полосы с n-ямками этого устройства будут диффундировать во время производства в один слой.Обращает на себя внимание разница в толщине области пространственного заряда база-коллектор из-за разных напряжений коллектор-эмиттер. В разнице электрического поля между фототранзистором 50 B Center E и 100 B Edge E изображен фототранзистор. Из-за более низкой концентрации легирования внутри основания очевидно, что фототранзистор 50 B Center E имеет более широкие области пространственного заряда, но меньшую напряженность электрического поля по сравнению с фототранзистором 100 B Edge E .Более тонкие области пространственного заряда и, следовательно, более высокая напряженность электрического поля в них приведут к более быстрой составляющей дрейфа. Это можно увидеть в разделе результатов о пропускной способности (раздел 5.3.2).
Смоделированная напряженность электрического поля для фототранзистора 50 B Center E при трех различных напряжениях В CE .
Границы области пространственного заряда при В CE = −2 В и −10 В для фототранзистора 50 B Center E .
Поперечное сечение напряженности электрического поля в центре эмиттера фототранзистора 50 B Center E и 100 B Edge E .
5.2. Определение характеристик постоянного тока
Определение характеристик постоянного тока было разделено на две разные схемы измерения. Во-первых, были охарактеризованы выходные характеристики, а во-вторых, была измерена спектральная чувствительность.
5.2.1. I
C в сравнении с V Семейство кривых CE и чувствительность на длине волны 850 нмДля характеристики модели I C vs. V Семейство кривых CE (выходные характеристики) был использован источник света с длиной волны 850 нм. Рабочая точка была изменена путем изменения напряжения коллектор-эмиттер В CE от 0 В до –13 В и оптической мощности между –37,7 дБм и –8,3 дБмВт. Таким образом, мощность света изменялась оптическим аттенюатором и контролировалась с помощью измерителя оптической мощности. Источник-измеритель-блок (SMU) использовался, с одной стороны, для изменения напряжения коллектор-эмиттер, а с другой стороны, для измерения тока коллектора, соответственно.Базовый контакт остался плавающим. изображает выходные характеристики фототранзистора 100 × 100 мкм 2 50 B Center E . На этом рисунке видно, что для напряжений от В CE до -13 В сквозной провод не происходит. Все остальные устройства показывают почти такую же выходную характеристику, как и изображенный.
Выходные характеристики фототранзистора 100 × 100 мкм 2 50 B Center E на 850 нм для разной оптической мощности с плавающей базой.
Расчетная чувствительность по постоянному току для фототранзисторов 50 B Center E и 100 B Edge E 100 × 100 мкм 2 при В CE = −10 В. Чувствительность уменьшается с увеличением мощности оптического света из-за уменьшения усиления фототранзистора, что вызвано изменением рабочей точки, как описано в [13]. Таким образом, более высокая мощность оптического света индуцирует высокий ток коллектора I C , что приводит к тому, что плотность тока превышает критическую плотность тока j c ∼ N C ( N C — концентрация легирования коллектора), определяемая эффектом Кирка [23,24] (также называемым эффектом выталкивания базы).Из-за концентрации легирования 5 × 10 13 см −3 в слое коллектора (это толстый p-эпитаксиальный слой) вместо обычных уровней легирования коллектора выше 10 15 см −3 , критический плотность тока снижается примерно на два порядка. Следовательно, даже при довольно низких токах коллектора коэффициент усиления по току β уменьшается с увеличением входной оптической мощности.
Чувствительность по постоянному току фототранзисторов 100 × 100 мкм 2 50 B Center E и 100 B Edge E на 850 нм при В CE = -10 В.
При слабой оптической мощности фототранзистор 50 B Center E показывает более высокое усиление из-за более низкой легированной базы и, следовательно, более высокое собственное усиление по току β . Фототранзистор 100 B Quad E имеет из-за большей площади эмиттера немного более высокую чувствительность, чем фототранзистор 100 B Edge E . Для всех фототранзисторов чувствительность не сильно меняется для разных В CE , поскольку ток коллектора I C меньше зависит от разных В CE в передней активной области (см.).В зависимости от постоянного тока для трех фототранзисторов 100 × 100 мкм 2 при различных В CE и различной оптической мощности показаны.
Таблица 1
Чувствительность по постоянному току в А / Вт для трех фототранзисторов 100 × 100 мкм 2 для трех различных напряжений коллектор – эмиттер на длине волны 850 нм и оптической мощности –37,7 дБм и –15,5 дБм.
| P opt = −37,7 дБм | P opt = −15.На 5 дБм = −2 V | V CE = −5 V | V CE = −10 V | ||||||||
|---|---|---|---|---|---|---|---|---|---|---|---|
| 50 B Центр E | .126,37 | 2.01 | 2.03 | 2.07 | |||||||
| 100 B Край E | 3.50 | 3.51 | 3.52 | 2.00 | 2.02 | 3 2.05||||||
| 3,57 | 3,57 | 3,59 | 2,63 | 2,65 | 2,68 | ||||||
5.2.2. Спектральная чувствительность
Спектральная чувствительность фототранзисторов измерялась с помощью монохроматора.Его использовали для изменения длины волны света от 400 до 900 нм. Таким образом, мощность оптического света монохроматора изменяется в пределах от -35,7 дБмВт до -26 дБмВт, как показано на рис. Выходная оптическая мощность монохроматора с присоединенным оптоволокном измерялась калиброванным эталонным фотодиодом. Затем волокно было настроено на фототранзисторы, в результате чего весь свет попадал в их светочувствительную область. SMU использовался для установки напряжения коллектор-эмиттер и измерения тока эмиттера.Затем рассчитывалась чувствительность на основе измеренного тока эмиттера и этой мощности падающего света. b показывает чувствительность фототранзисторов 50 B Center E и 100 B Edge E 100 × 100 мкм 2 фототранзисторов при В CE = −2 В. Фототранзистор 50 B Center E показывает более высокую чувствительность по сравнению с фототранзистором 100 B Edge E (сравните с). Максимальная чувствительность измеряется для всех фототранзисторов в красном диапазоне длин волн.Колебания, которые можно увидеть в спектральной чувствительности, связаны с влиянием оптических помех в полном оксидном и пассивирующем пакете. Их можно избежать, применив этап травления оптического окна вместе с антиотражающим покрытием поверх светочувствительной области.
Спектральные измерения: (а) излучаемая оптическая мощность монохроматора и (б) спектральная чувствительность 100 × 100 мкм 2 50 B Center E и 100 B Edge E фототранзисторы при В CE = −2 В.
5.3. Характеристики переменного тока: чувствительность и полоса пропускания
Измерения чувствительности фототранзисторов на переменном токе проводились на трех разных длинах волн: 410 нм, 675 нм и 850 нм. При использовании одной и той же оптической силы света для упомянутых длин волн разные токи коллектора I C будут возникать, с одной стороны, из-за разной чувствительности на каждой длине волны, а с другой стороны, из-за разной энергии на фотон для разного цвета света. Поэтому сравнение отдельных длин волн не будет абсолютно правильным, поскольку фототранзистор будет работать в разных рабочих точках для разных длин волн.Для лучшего сравнения было применено выравнивание мощности оптического света для обеспечения того же тока коллектора I C . Таким образом, средняя мощность оптического света на длине волны 410 нм была установлена на уровне –12,7 дБмВт, на длине волны 675 нм — на уровне –19,2 дБмВт, а на длине волны 850 нм — на уровне –15,8 дБмВт. Из-за использованных лазерных источников коэффициент экстинкции составлял 2,00, 2,74 и 1,48 для 410 нм, 675 нм и 850 нм соответственно. Во время определения характеристик переменного тока для фототранзисторов также использовались разные рабочие точки.Кроме того, напряжение коллектор-эмиттер В CE было установлено на -2 В, -5 В и -10 В, а базовый ток I B изменялся от плавающего состояния (0 мкА) до 1 мкА, 2 мкА, 5 мкА и 10 мкА. Тройник смещения вместе с базовым резистором на кристалле использовался для установки различных рабочих точек.
5.3.1. Чувствительность к переменному току
Динамическая чувствительность была измерена для трех упомянутых длин волн на частоте 630 кГц. Фототранзисторы были подключены по схеме эмиттерного повторителя, и их выходной сигнал был емкостным образом связан с осциллографом через тройник смещения.Все фототранзисторы обладают довольно малой чувствительностью, в основном из-за небольшой площади эмиттера. Эти небольшие эмиттерные области предполагают более высокую вероятность рекомбинации зарядов внутри базовой области. Это вызвано тем, что заряды должны преодолевать большие расстояния, чтобы достичь области эмиттера. Только заряды, которые генерируются непосредственно под эмиттером, должны пройти через базу лишь небольшое расстояние, чтобы достичь области пространственного заряда база-эмиттер. Однако представленные здесь фототранзисторы предназначены для достижения высокой пропускной способности.В динамических характеристиках различных фототранзисторов при разных напряжениях коллектор-эмиттер В CE представлены плавающая база и разные длины волн. Наивысшая чувствительность 2,89 А / Вт достигается для фототранзистора 100 B Quad E при В CE = −10 В и 675 нм. При применении вышеупомянутых базовых токов чувствительность немного снижается. Это вызвано возникающим эффектом выталкивания базы и уменьшением коэффициента усиления по току β из-за высоких токов базы [23,24].В соответствии с требованиями правил проектирования фототранзистор 100 B Edge E имеет немного большую площадь эмиттера, что также приводит к немного более высокой чувствительности по сравнению с фототранзистором 50 B Center E .
Таблица 2
Динамическая чувствительность в A / W для трех фототранзисторов 100 × 100 мкм 2 для двух различных напряжений коллектор-эмиттер при 410 нм, 675 нм, 850 нм и плавающей базе.
| λ = 410 нм | λ = 675 нм | λ = 850 нм | |||||||
|---|---|---|---|---|---|---|---|---|---|
| CE | 6 902| 909 V CE = −10 V | V CE = −2 V | V CE = −10 V | V CE = −2 V | CE = −10 V | | |||
| 50 B Центр E | 0.45 | 0,48 | 1,93 | 1,95 | 1,34 | 1,36 | |||
| 100 B Кромка E | 0,47 | 0,51 | 37 2,0106 9100,51 | 37 2,0106 910 1,51 37 2,0106 910 100 B Quad E0,71 | 0,74 | 2,81 | 2,89 | 2,20 | 2,34 |
5.3.2. Полоса пропускания
Характеристика полосы пропускания фототранзисторов была проведена с помощью векторного анализатора цепей (ВАЦ).Фототранзисторы 50 B Center E и 100 B Edge E показывают примерно одинаковую полосу пропускания. Фототранзистор 100 B Quad E обеспечивает меньшую полосу пропускания из-за большей площади эмиттера и, следовательно, большей емкости база-эмиттер C BE . Для фототранзистора 50 B Center E высокая полоса пропускания в основном вызвана тонкой эффективной шириной базы и, следовательно, коротким временем прохождения базы, а также меньшими емкостями перехода C BC и C BE .Что касается фототранзистора 100 B Edge E , который даже немного быстрее, в широкой полосе частот преобладает немного более высокая напряженность электрического поля в областях пространственного заряда. Эти области пространственного заряда немного меньше из-за более высокой области легированного основания. Более того, фототранзисторы небольшого размера демонстрируют более высокую пропускную способность по сравнению с фототранзисторами большого размера. Здесь основными причинами являются меньшая емкость база-коллектор и меньшая емкость по периметру. Более широкая полоса пропускания может быть достигнута путем увеличения напряжения коллектор-эмиттер В CE , а также путем приложения тока базы I B .Более высокое значение В CE приводит к более широким областям пространственного заряда, вызывая меньшие емкости перехода C BE и C BC и, как следствие, более тонкую эффективную ширину базы, вызывая более короткое время прохождения базы. Кроме того, более высокое значение В CE вызывает более сильную напряженность электрического поля внутри устройства (см.). показывает зависимость частотной характеристики от размера фототранзисторов, а также от напряжения коллектор-эмиттер В CE на длине волны 850 нм для фототранзистора 100 B Edge E .Ширина полосы по уровню −3 дБ составляет 12,0 МГц и 25,7 МГц для фототранзисторов размером 100 × 100 мкм 2 и 14,2 МГц и 50,7 МГц для фототранзисторов размером 40 × 40 мкм 2 при В CE = −2 В. и −10 В соответственно.
Частотная характеристика 40 × 40 мкм 2 и 100 × 100 мкм 2 100 B Edge E на длине волны 850 нм и с плавающей базой.
В полосах пропускания для фототранзистора 100 × 100 мкм 2 100 B Edge E изображены фототранзисторы на длине волны 850 нм и различные рабочие точки.Полоса пропускания увеличивается с увеличением тока базы до тех пор, пока плотность тока коллектора не достигнет максимума. В этой точке наибольшее однородное электрическое поле существует в области пространственного заряда база – коллектор. При подаче более высокого тока коллектора заряды больше не могут полностью переноситься электрическим полем [22]. За пределами максимумов в базе возникает эффект выталкивания, который приводит к распространению эффективной базы в коллектор [23,24]. Таким образом, эффективная ширина базы становится шире, а время прохождения базы увеличивается, что в соответствии с формулой.(2) к уменьшенной полосе пропускания. Однако следует отметить, что положение максимумов зависит от напряжения коллектор – эмиттер В CE . Следовательно, увеличение на В CE приводит также к увеличению соответствующей максимальной плотности тока коллектора и, следовательно, к увеличению тока базы для максимума полосы пропускания.
Зависимость полосы пропускания от базового тока при трех различных напряжениях В CE для 100 × 100 мкм 2 100 B Edge E на 850 нм.
Разница в полосе пропускания на разных длинах волн для фототранзистора 40 × 40 мкм 2 100 B Edge E при В CE = -10 В показана в. Ширина полосы по уровню −3 дБ составляет 50,7 МГц на 850 нм, 76,9 МГц на 675 нм и 60,5 МГц на 410 нм для этого фототранзистора. В полосах пропускания для трех представленных фототранзисторов на В CE показаны = −2 В и −10 В и плавающая база на трех разных длинах волн.В верхней части таблицы представлены результаты для устройств 40 × 40 мкм 2 , а в нижней — для устройств 100 × 100 мкм 2 . Примечательно, что фототранзистор 100 B Quad E показывает более высокую полосу пропускания для В CE = −2 В по сравнению с обоими другими фототранзисторами. Это вызвано меньшим расстоянием диффузии генерируемых зарядов. Фототранзистор 100 B Edge E обеспечивает максимальную ширину полосы пропускания из-за большей напряженности электрического поля в областях пространственного заряда (см.).Однако все устройства достигают максимальной полосы пропускания на длине волны 675 нм благодаря оптимальной глубине проникновения света. Таким образом, основная часть зарядов генерируется в толстой области объемного заряда база-коллектор и, следовательно, непосредственно в зоне электрического поля.
Частотная характеристика фототранзистора 40 × 40 мкм 2 100 B Edge E Фототранзистор на 410 нм, 675 нм, 850 нм и В CE = -10 В.
Таблица 3
Полоса пропускания в МГц трех представленных фототранзисторов на 410 нм, 675 нм, 850 нм, а также с плавающей базой и В CE = -2 В и -10 В.В верхней таблице представлены значения для фототранзисторов 2 40 × 40 мкм, а в нижней таблице — для фототранзисторов 2 100 × 100 мкм.
| λ = 410 нм | λ = 675 нм | λ = 850 нм | ||||||||||||
|---|---|---|---|---|---|---|---|---|---|---|---|---|---|---|
V CE = CE −2 V 9039 = −10 В| В CE = −2 В | В CE = −10 В | В CE = −2 V | V CE = 10 В | | ||||||||||
| 50 B Центр E | 10.7 | 57,5 | 9,6 | 67,0 | 12,8 | 50,0 | ||||||||
| 100 B Край E | 14,4 | 60,5 | 121049 | 60,5 | 121049 | 4949 | 49 | 100 B Quad E | 20,2 | 54,2 | 18,8 | 60,3 | 18,6 | 31,6 |
| 1 50390 | ||||||||||||||
| 1 501 B8 | 36,5 | 9,1 | 54,0 | 10,5 | 25,1 | |||||||||
| 100 B Край E | 12,2 | 40,1 | 49 12,240,1 | 49 12,09 4949 | 100 B Quad E | 16,6 | 34,0 | 16,1 | 51,6 | 15,8 | 21,4 | |||
6. Заключение
В этой работе мы представляем три типа оптимизированных скоростных датчиков. в стандартном процессе 180 нм CMOS без модификаций.Каждый тип фототранзистора был изготовлен с площадью 40 × 40 мкм 2 и 100 × 100 мкм 2 . Для достижения высокой пропускной способности в переходе база – коллектор использовалась PIN-структура. Поэтому был использован специальный исходный материал, состоящий из подложки p + и низколегированного слоя epi p — , выращенного поверх нее. Благодаря этому низколегированному эпи-слою образуется толстая область пространственного заряда, которая необходима для быстрого разделения генерируемых зарядов, вызванных глубоко проникающим светом.Поскольку фототранзисторы были разработаны для высокоскоростных приложений, дальнейшее увеличение полосы пропускания было достигнуто за счет небольших площадей эмиттера. Это уменьшение площади эмиттера приводит также к уменьшению емкости база-эмиттер. Однако малые площади излучателя невыгодны для достижения высокой чувствительности. Таким образом, наши фототранзисторы обеспечивают лишь небольшую динамическую чувствительность до 2,89 А / Вт, а также чувствительность по постоянному току до 6,44 А / Вт. Кроме того, фототранзисторы достигают полосы пропускания до 50,7 МГц на длине волны 850 нм, 76.9 МГц при 675 нм и 60,5 МГц при 410 нм при В CE = -10 В и в условиях плавающей базы. Эти результаты вызваны малой емкостью и высокой напряженностью электрического поля в областях пространственного заряда. Кроме того, было выполнено моделирование напряженности электрического поля и областей пространственного заряда. По сравнению с фототранзисторами, описанными в [13] и [14], которые были реализованы по технологии КМОП 0,6 мкм, ширина полосы пропускания увеличена более чем в 5 раз. Следовательно, эти фототранзисторы хорошо подходят для приложений, в которых используется высокоскоростной фотодетектор. необходим с внутренним усилением тока.Содержательное сравнение представленных фототранзисторов с другими фототранзисторами довольно сложно, поскольку устройство сильно нелинейно, а его рабочие условия зависят от многих факторов (например, напряжения коллектор-эмиттер, размера устройства, мощности оптического излучения, длины волны, дополнительной базы токи и др.). Однако авторы попытались привести сравнение для света с длиной волны 850 нм, показанного на рис. Возможными применениями представленных фототранзисторов могут быть, например, трехмерные камеры, быстрые оптопары и оптические приемники данных.По сравнению с обычным PIN-фотодетектором, использующим оптимизированный PIN-фотодиод (с чувствительностью 0,4 А / Вт), представленные устройства можно использовать для усиления входного сигнала до коэффициента 7,2, что соответствует усилению оптического сигнала в диапазоне 8,6 дБ.
Таблица 4
Сравнение фототранзисторов CMOS и BiCMOS на длине волны 850 нм.
| Реф. | Технология | Тип устройства | Размер (мкм 2 ) | Длина волны (нм) | P opt (дБм) | Чувствительность (A / W) | 90 − f (МГц) | GBW (A / W MHz) | ||||
|---|---|---|---|---|---|---|---|---|---|---|---|---|
| [11] | 0.35 мкм SiGe HBT BiCMOS | NPN | 6 × 10 | 850 | −17 | 2,7 | 2000 | 5400 a | ||||
| [12] | me | e | e | e | 21 × 25 | 850 | — | 5,2 | — | — | ||
| [14] | 0,6 мкм КМОП | PNP | 100 × 100 | 850 | 14 б | 25.2 | ||||||
| [15] | 0,35 мкм CMOS | PNP | 35 × 35 | — | — | — | <1 | — | ||||
| CMOS [1710] | NPN | 60 × 60 | 850 | — | 0,34 | 0,15 | 0,05 | |||||
| Эта работа | 0,18 мкм181037 910 910 910 910 | −15.8 | 1,5 | 25,7 b | 38,6 | |||||||
| 40 × 40 | 1,44 | 50,7 b | 73,0 | |||||||||
Science Fund 2 (Austrian Funding). признан проект P21373-N22.
Список литературы
1. Циммерманн Х. 2-е изд. Springer-Verlag; Берлин, Гейдельберг: 2010. Интегрированная кремниевая оптоэлектроника. [Google Scholar] 2. Гейст Дж., Залевски Э.F. Квантовый выход кремния в видимом диапазоне. Appl Phys Lett. 1979. 35 (7): 503–506. [Google Scholar] 3. Кристенсен О. Квантовая эффективность внутреннего фотоэффекта в кремнии и германии. J Appl Phys. 1976; 47: 689–695. [Google Scholar] 4. Шредер Д.К., Томас Р.Н., Шварц Дж. Абсорбция свободных носителей заряда в кремнии. Твердотельные схемы IEEE J. 1978. 13 (1): 180–187. [Google Scholar]5. Свобода Р., Циммерманн Х. Монолитно-интегрированный кремниевый оптический приемник 11 Гбит / с для длины волны 850 нм.В: Международная конференция по твердотельным схемам IEEE, Дайджест технических статей ISSCC, vol. 49; 2006. с. 240–1.
6. Шауб Дж. Д., Ли Р., Чутак С. М., Кэмпбелл Дж. К. Высокоскоростные монолитные кремниевые фотоприемники на высокоомных и КНИ подложках. IEEE J Lightwave Technol. 2001. 19 (2): 272–278. [Google Scholar] 7. Ciftcioglu B., Zhang L., Zhang J., Marciante J.R., Zuegel J., Sobolewski R. Интегрированные кремниевые PIN-фотодиоды с использованием глубокой N-лунки по стандартной 0,18-мкм технологии CMOS. IEEE J Lightwave Technol.2009. 27 (15): 3303–3313. [Google Scholar] 8. Давидович М., Зак Г., Шнайдер-Хорнштейн К., Циммерманн Х. Датчик дальности TOF на 90 нм CMOS, способный подавлять окружающий свет 180 клк. Датчики IEEE. 2010: 2413–2416. [Google Scholar] 9. Кова С., Гиони М., Лакайта А., Самори К., Заппа Ф. Лавинные фотодиоды и схемы гашения для однофотонного детектирования. Appl Opt. 1996; 35 (12): 1956–1976. [PubMed] [Google Scholar]10. Панчери Л., Стоппа Д. Малошумящие однофотонные лавинные диоды в 0.Технология CMOS 15 мкм. В: Европейская конференция по исследованиям твердотельных устройств, Труды ESSDERC; 2011. с. 179–82.
11. Инь Т., Паппу А.М., Апсель А.Б. Недорогие, высокоэффективные и быстродействующие SiGe-фототранзисторы в коммерческом BiCMOS. IEEE Photonics Technol Lett. 2006. 18 (1): 55–57. [Google Scholar] 12. Лай К.С., Хуанг Дж.С., Сюй К.Й.Дж. Высокочувствительный фотодетектор по стандартной технологии SiGe BiCMOS. IEEE Electron Device Lett. 2007. 28 (9): 800–802. [Google Scholar] 13. Костов П., Шнайдер-Хорнштейн К., Циммерманн Х. Фототранзисторы для КМОП-оптоэлектронных интегральных схем. Sens Actuators, A. 2011; 172: 140–147. [Google Scholar] 14. Костов П., Габерл В., Циммерманн Х. Интегрированные фототранзисторы видимого и ближнего ИК-диапазона в КМОП-технологии. Твердотельный электрон. 2011; 65–66: 211–218. [Google Scholar] 15. Ху А., Чодаварапу В.П. КМОП-оптоэлектронный синхронный усилитель со встроенной матрицей фототранзисторов. IEEE Trans Biomed Circuits Syst. 2010. 4 (5): 274–280. [PubMed] [Google Scholar] 16. Кешник К., Циммерманн Х., Зигебрехт П. Оптические приемники на основе кремния в технологии BiCMOS для передовых оптоэлектронных интегральных схем. Mater Sci Semiconduct Process. 2000. 3: 395–398. [Google Scholar] 17. Карусоне А.К., Ясотаран Х., Као Т. Рекомендации по масштабированию технологии CMOS для оптических приемников с пропускной способностью несколько Гбит / с со встроенными фотодетекторами. Твердотельные схемы IEEE J. 2011; 46 (8): 1832–1842. [Google Scholar]18. Костов П., Габерл В., Циммерманн Х. Высокоскоростные фототранзисторы PNP PIN в КМОП-процессе 0,18 мкм, IEEE ESSDERC 2011.С. 187–90.
19. Сэндидж Р.В., Коннелли Дж. А. Оптоискатель отпечатков пальцев, использующий боковые биполярные фототранзисторы в стандартном CMOS-процессе. IEEE IEDM. 1995: 171–174. [Google Scholar] 20. Чжан В., Чан М., Ко П.К. Новый КМОП-датчик изображения с высоким коэффициентом усиления, использующий плавающий полевой МОП-транзистор с N-ячейкой / затвором. IEEE IEDM. 1998: 1023–1025. [Google Scholar] 21. Уинстел Г., Вейрих К. Спрингер; Берлин, Гейдельберг: 1986. Optoelektronik II. п. 97. [Google Scholar] 22. Сзе С.М., Нг К.К. 3-е изд. Wiley; Нью-Йорк: 2006. Физика полупроводниковых приборов.[Google Scholar] 23. Кирк К. Теория падения частоты отсечки транзистора (fT) при высоких плотностях тока. IRE Trans Electron Devices. 1962: 164–174. [Google Scholar] 24. Уиттиер Р.Дж., Тремер Д.А. Усиление по току и спад частоты среза при больших токах. IEEE Trans Electron Devices. 1969; 16 (1): 39–57. [Google Scholar]Характеристики биполярного транзистора с изолированным затвором
Электрические измерения с высочайшим разрешением
Вертикальные биполярные транзисторы с изолированным затвором (IGBT) — один из наиболее важных типов дискретных силовых транзисторов.Эти устройства были разработаны для более эффективной работы и более быстрого переключения. IGBT сочетает в себе простые характеристики управления затвором полевых МОП-транзисторов с высокой силой тока и низким напряжением насыщения биполярных транзисторов.1
В общем, для силовых транзисторов двумя ключевыми параметрами являются напряжение блокировки, а именно максимальное напряжение, которое устройство может блокировать в выключенном состоянии, и сопротивление в открытом состоянии, которое должно быть как можно более низким. И IGBT, и MOSFET обычно изготавливаются с воротами для траншеи.Затворы траншеи позволяют увеличивать как напряжение блокировки, так и рабочий ток в открытом состоянии2
Исследование характеристик устройства включает множество различных типов механических и электрических испытаний. Понимание уровня легирования и типа носителя в разных местах устройства имеет решающее значение для конструкции и производительности устройств IGBT. Полировка поперечного сечения и полировка передней поверхности — это два распространенных метода подготовки образца для экспонирования активных слоев устройства для стандартных измерений профиля легирующей примеси.К этим же образцам можно применить sMIM, чтобы получить более детальное представление о структуре устройства, помимо информации о допировании и типе носителя.
Рис. 1. Емкостные данные MIM, наложенные на топографию, демонстрируют динамический диапазон режима для отображения металлов, легированных областей и изоляторов на одном изображении. Изображение показывает большую детализацию, чем другие электрические моды, на легированных образцах с поперечным сечением
.На рисунке 1 показан sMIM-C (емкостной), наложенный на топографию устройства IGBT, подготовленного для PrimeNano компанией ChipWorks.Динамический диапазон измерения sMIM включает металлы, легированные области и диэлектрические материалы, и на изображении четко видны такие особенности, как диэлектрический оксидный слой затвора, металлический контакт затвора и область полупроводникового эмиттера, а также дефекты, которые, вероятно, являются остатками процесс полировки. Детали на изображении демонстрируют диапазон техники MIM.
Рис. 2. СЭМ-изображение со вставкой SCM поперечного сечения IGBT-транзистора с преимущественным травлением.Изображение SCM насыщается в траншеях ворот и металлах. Эмиттер и легированная подложка представлены немного подробнее.
SEM и соответствующее изображение SCM, измеренные Chipworks на аналогичном устройстве IGBT, рис. 2, показывают поперечное сечение эмиттера, поперечное сечение показывает соединение эмиттера непосредственно с вольфрамовой контактной полосой. Вольфрамовые контакты, по-видимому, были протравлены, а не подвергнуты химико-механической полировке (CMP) 2
Рисунок 3 sMIM dC / dV Амплитудное изображение поперечного сечения IGBT.На изображении с высокой степенью детализации выделены области источника и тела, легированные примесью. Область ворот траншеи с деталями остатков полироли.
Аналогичная часть IGBT была подготовлена для PrimeNano для визуализации с помощью системы ScanWave ™. Метод sMIM обеспечивает уровень информации, который обычно требует, чтобы и SEM, и SCM предоставили полный уровень структурных деталей устройства. Можно подумать, что использование sMIM может устранить требование о предпочтительном травлении легированных образцов для получения изображений с помощью SEM — процесса, требующего много времени и высококвалифицированных специалистов, что сокращает рабочий процесс.sMIM также предоставляет дополнительную информацию по SCM, имея лучшую чувствительность и более высокое разрешение.
ScanWave ™ в качестве стандартной функции имеет возможность отображать образец и предоставлять 6 дополнительных каналов данных, в зависимости от конкретных возможностей АСМ. Стандартные каналы MIM-C и R связаны с диэлектрической проницаемостью и проводимостью образца. Применяя модулированное смещение к образцу через зонд ScanWave ™ или держатель образца, мы можем получить амплитуду и фазу dC / dV и dR / dV для дополнительных 4 изображений; информация аналогична SCM, но с большей чувствительностью и более легким ответом на сигнал, чем традиционный SCM.
Для большинства полупроводниковых приложений амплитуда и фаза dC / dV предоставляют важную информацию о концентрации и полярности носителей соответственно. На Рисунке 3 показана амплитуда БТИЗ нескольких особенностей канавки затвора с уровнем детализации, не видимым на изображении SCM, показанном ранее. Источник и корпус, а также металлическая заглушка можно четко идентифицировать. Переходы n-p-n от источника к телу-подложке не проявляют нечетких граничных переходов, типичных для изображений SCM.
Использование sMIM для характеристики IGBT и полупроводниковых устройств в целом выигрывает от повышенной чувствительности к материалу, нечувствительности к линейным материалам (металлам, изоляторам и диэлектрикам), традиционно требующим вторичных методов для изображения. ScanWave ™ использует экранированные зонды и оптимизированную электронику для достижения простоты использования, что улучшает рабочий процесс определения характеристик устройства.
Список литературы
- Википедия, IGBT, запись; http: // ru.wikipedia.org/wiki/Insulated-gate_bipolar_transistor
- Веб-сайт Chipworks, URL; http://www.chipworks.com/en/technical-competitive-analysis/resources/blog/competitive-analysis-igbts-reveals-internal-workings/
Авторские права 2021. Все права защищены.
Биполярные переходные транзисторы (БЮТ)
Биполярные переходные транзисторы (БЮТ)Этот раздел никоим образом не расскажет вам все о транзисторах.Это просто даст вам общее представление о том, что такое транзисторы и как их можно использовать в автомобильной аудиосистеме. Два основных типа транзисторов — это биполярные транзисторы и полевые транзисторы.
Биполярный транзистор использует небольшой ток для управления большим током, как в реле. Биполярные транзисторы обычно имеют 3 вывода. Терминал управления называется базовым. Два других вывода известны как эмиттер и коллектор, и они несут практически весь ток, протекающий через транзистор.Есть 2 основные конфигурации биполярных транзисторов: одна — NPN, другая — PNP. Эти два очень похожи. Самая большая разница — это направление протекания тока через коллектор и эмиттер. Пока мы в основном обсудим NPN-транзистор.
Current Control:
Хорошо, я сказал, что транзистор вроде как реле. Помните, что для срабатывания реле необходимо, чтобы на катушке реле было определенное напряжение. Транзистор должен иметь небольшую разницу напряжений между базой и эмиттером.Требуемое напряжение обычно составляет около 0,6 вольт. На NPN-транзисторе база должна иметь положительное напряжение по отношению к эмиттеру. Посмотрите на диаграмму ниже. Он показывает схематический символ биполярного транзистора NPN (слева) и биполярного транзистора PNP. Обратите внимание на названия отдельных терминалов.
Одна из проблем, с которой сталкиваются установщики, — это необходимость надежного переключения реле, когда коммутационный выход управляющего устройства меньше 12 вольт, необходимых для срабатывания реле.На первой диаграмме вы можете видеть, что напряжение, приложенное к резистору, составляет 0 В постоянного тока, а контакты реле не замкнуты. На следующей диаграмме вы увидите, что к резистору приложено 12 В постоянного тока, а контакты реле замкнуты (потому что транзистор теперь проводит ток).
Вы, несомненно, заметили резистор, подключенный к базе транзистора. Это сделано для предотвращения повреждения транзистора. Если напряжение, приложенное к базе, больше, чем приблизительно.6 вольт (относительно эмиттера) транзистор может выйти из строя. Подумайте об этом так … (я знаю, что мои аналогии НЕУДАЧНЫ, но они помогут некоторым людям). Если бы вы включали свет с помощью лезвия на передней части бульдозера (не пытайтесь делать это дома, дети ), вам нужно будет очень точно установить лезвие, чтобы не повредить переключатель. Если вы соединили переключатель с бульдозерным отвалом с помощью резиновой ленты, бульдозерный отвал все равно может включить переключатель, и отвал может подняться настолько высоко, насколько это физически возможно, без разрушения переключателя.А что, если резинка слишком прочная или слишком слабая? Переключатель может быть поврежден, если резинка окажется слишком прочной или, если резинка слишком слабая, переключатель может вообще не включиться (даже в самом верхнем положении бульдозерного отвала). То же самое и с транзистором. Если резистор с низким сопротивлением соединен последовательно с базой и на резистор подается высокое напряжение, транзистор все равно может выйти из строя. Если резистор имеет очень высокое сопротивление и на него подается напряжение, транзистор может быть открыт не полностью.Если транзистор включен только частично, это означает, что будет падение напряжения между коллектором и эмиттером транзистора, и транзистор может нагреться.
Если транзистор подключен, как показано на предыдущей схеме, на нем будет падение напряжения, потому что транзистор не может быть включен настолько, чтобы на нем не было абсолютно никакого напряжения, пока через него протекает ток. Поскольку на транзисторе происходит падение напряжения и через него протекает ток, происходит рассеяние мощности в виде тепла.Количество выделяемого тепла определяется рассеиваемой мощностью. Если транзистор не установлен на радиаторе, он может быть разрушен из-за тепла.
Теперь, просто для удовольствия, нажмите, потяните или перетащите указатель мыши на изображение ниже. Следите за вольтметром и подвижным контактом реле.
Параметры проекта:
В этом разделе приведены некоторые, но далеко не все критические параметры.
Beta:
Один параметр сообщает вам величину усиления по постоянному току, которую дает вам транзистор.Обычно он называется beta или hfe . Если бета транзистора составляет 150 и транзистор имеет ток 2 ампера, протекающий через коллектор и эмиттер, ток, протекающий через базу, будет 2/150 или 0,013 ампера тока.
Current:
Еще одна важная спецификация — это номинальный ток транзистора. Обратите внимание, что все указанные номинальные токи приведены для температуры транзистора 25 ° C или примерно 77 градусов по Фаренгейту. «Безопасные» токопроводящие способности значительно уменьшаются при повышении температуры.Стандартная процедура — использовать транзистор, рассчитанный на гораздо больший ток, чем обычно требуется.
Напряжение:
В большинстве проектных ситуаций максимальное напряжение, которое будет приложено к транзистору, очень важно. Слишком большое напряжение повредит транзистор так же быстро, как и слишком большой ток. Если вы используете его для простого включения реле, это не очень критично. Есть несколько транзисторов, которые не могут выдержать напряжение между эмиттером и коллектором минимум 15 вольт.
Рассеиваемая мощность:
Раньше рассматривалось рассеяние мощности применительно к транзисторам.Помните, что всякий раз, когда существует разница потенциалов (напряжений) между эмиттером и коллектором И ток, протекающий через транзистор, будет рассеиваться мощность. А когда у вас есть рассеивание мощности, будет выделяться тепло. Как правило, номинальная мощность транзистора определяется типом его корпуса. На фото ниже представлены несколько стилей корпуса. Слева направо корпус TO-92 рассчитан примерно на 0,5 Вт; корпус ТО-220, 100-125 Вт; корпус ТО-218 и ТО-3П, 125-150 Вт; корпус ТО-264, 200 Вт.Всем, кроме корпуса TO-92, для работы на указанной мощности требуется радиатор. Для рассеивания мощности более 1 Вт требуются тяжелые радиаторы.
B = база C = коллектор E = эмиттер
На этой фотографии вы видите разницу в размере между реальным кусочком силикона и размером упаковки. Это показывает, что размер кремния значительно меньше размера корпуса, в котором он находится. Это MJE15030. Корпус этого транзистора имеет размеры примерно 0.6 дюймов на 0,4 дюйма. Силиконовая матрица внутри упаковки имеет квадрат примерно 0,11 дюйма.
Что такое фототранзистор? Определение, конструкция, работа, характеристика фототранзистора
.Определение : Фототранзистор — это устройство, которое может определять уровень падающего излучения и, соответственно, изменять поток электрического тока между эмиттером и выводом коллектора. Это трехслойное полупроводниковое устройство, которое состоит из светочувствительной базовой области .По сути, это транзистор, действие которого зависит от освещения. Отсюда и название фототранзистора.
Фототранзистор в основном является усовершенствованием фотодиода. И фотодиод, и фототранзистор являются светочувствительными устройствами, но чувствительность фототранзистора несколько выше, чем у фотодиода. Поскольку фототранзистор имеет возможность давать большее усиление, чем у фотодиода. Он похож на обычный BJT , но с той лишь разницей, что в фототранзисторе практически существует базовая область, но она не подключена к внешнему источнику питания.
Это означает, что, как и в обычном BJT, базовый ток используется для управления схемой, однако в фототранзисторе световая энергия, падающая на базовую область, действует как общий вход устройства.
Говорят, что фототранзистор демонстрирует совместную работу фотодиода и обычного транзистора . Работает по принципу Фотоэлектрический эффект . Поскольку он изменяет световой сигнал, падающий на его поверхность, в его электрическую эквивалентную форму. А действие транзистора позволяет ему выполнять усиление тока, протекающего через него.
Содержимое: Фототранзистор
- Строительство
- Символ
- рабочий
- Кривая характеристик
- Преимущества
- Недостатки
- Приложения
- Ключевые слова
Конструкция фототранзистора
Как мы уже говорили, фототранзистор — это не что иное, как обычный транзистор, действие которого зависит от падающего излучения, падающего на его базу. Во время создания фототранзистора область базы и коллектора имеет большую площадь по сравнению с обычным BJT.
На рисунке ниже представлена конструктивная структура фототранзистора NPN:
Здесь, как мы видим, свет в основном может падать на коллекторный переход базы. Первоначально фототранзисторы изготавливались из кремния или германия в качестве основного материала, который в результате обеспечивает структуру гомоперехода. Однако в последнее время они строятся с использованием таких материалов, как галлий или арсенид. Тем самым обеспечивается структура гетероперехода.Это потому, что эти структуры демонстрируют большую эффективность преобразования. Это означает, что они более способны преобразовывать световую энергию в электрическую по сравнению с транзисторами с гомопереходом.
Фототранзисторы в основном заключены в металлический корпус, который состоит из линзы в верхней части для сбора падающего излучения.
Символ фототранзистора
На рисунке ниже представлено символическое изображение фототранзистора:
. Здесь символическое представление почти аналогично обычному BJT, но единственным отличием является наличие двух направленных внутрь стрелок в базовой области, которые показывают падающее световое излучение.
Работа фототранзистора
Работа фототранзистора зависит от интенсивности излучения, падающего на его базовую область. Однако его работа почти аналогична работе обычного транзистора; вариация заключается во входном токе, который управляет схемой. А в случае фототранзистора падающий свет генерирует ток возбуждения.
На рисунке ниже представлена схема смещения фототранзистора:
На схеме хорошо видно, что базовая область не подключена к внешнему питающему напряжению и используется в качестве области падения излучения.Только коллекторная область подключена к положительной стороне источника питания вместе с эмиттером, который подключен к отрицательной стороне. Однако выходной сигнал берется на выводе эмиттера транзистора.
Когда не допускается попадание какого-либо света в базовую область транзистора, из-за изменения температуры движение неосновных носителей через переход генерирует очень небольшой ток через транзистор, который является током обратного насыщения, в основном называемым темновым током.Здесь базовый ток I B в основном равен 0 . Здесь в этом случае выходной ток будет меньше по сравнению с предусмотренным питанием. Но когда на основание транзистора попадает определенное количество световой энергии, генерируется пара электронов и дырок. Приложенное электрическое поле заставляет электроны перемещаться в область эмиттера, тем самым генерируя большой электрический ток.
На рисунке ниже представлена схема фототранзистора:
По мере увеличения интенсивности света, падающего в области основания, ток через устройство также увеличивается.Здесь генерируемый фототок в значительной степени зависит от освещения, обеспечиваемого основанием.
Характеристика фототранзистора
На рисунке ниже представлена характеристика фототранзистора:
.Здесь ось абсцисс представляет напряжение, приложенное к выводу коллектор-эмиттер транзистора, а ось ординат представляет ток коллектора, протекающий через устройство, в миллиамперах. Поскольку все кривые на приведенном выше рисунке ясно показывают, что ток увеличивается с интенсивностью излучения, которое попадает в базовую область.
Кроме того, на рисунке ниже показано изменение тока базы с изменением интенсивности света.
Здесь ось абсцисс представляет уровень освещенности, тогда как ось ординат представляет собой эквивалентный генерируемый базовый ток.
Преимущества фототранзистора
- Это высокочувствительное оптоэлектронное устройство.
- Он менее сложный и недорогой. Фототранзисторы
- обеспечивают большой выходной ток с высоким коэффициентом усиления.
Недостатки фототранзистора
- Обеспечивает низкочастотный отклик.
- В случае, когда обеспечивается небольшое количество освещения, схема не может эффективно его обнаруживать.
- Скачки напряжения более сильны в фототранзисторах, чем в фотодиоде. На фототранзисторы
- влияет изменение электромагнитной энергии.
Применение фототранзистора
Области применения фототранзисторов:
- В управлении и обнаружении света : Поскольку фототранзисторы являются очень чувствительными датчиками света.Таким образом, они широко используются в приложениях для обнаружения и управления освещением.
- Для индикации уровня и реле : Устройство находит свое применение для индикации уровня в некоторых системах из-за их светочувствительности.
- В счетных системах : Фототранзисторы могут быть эффективно использованы в счетных системах. Поскольку он обладает огромной способностью одновременно работать как фотодиод и транзисторы. Таким образом, отказ питания не вызовет серьезных негативных последствий для системы.
- В считывателях перфокарт : Фототранзисторы широко используются для считывания перфокарт.
Ключевые термины, относящиеся к фототранзистору
- Фотодиод : Фотодиод — это полупроводниковый прибор с двумя выводами, который генерирует электрический ток, когда pn переход освещается световой энергией. Он работает по принципу фотоэлектрического эффекта.
- Темновой ток : Обратный ток, протекающий через устройство, когда на него не подается световая энергия.Этот ток в основном протекает из-за движения неосновных носителей заряда.
- BJT : BJT — это аббревиатура, используемая для обозначения биполярного переходного транзистора. Это устройство с 3 выводами, эмиттер, база и коллектор, которое используется для переключения и усиления.
Хотя фототранзисторы являются высокочувствительными устройствами, устройство работает несколько медленнее. Это явно означает, что с повышенной чувствительностью основной недостаток связан с его на и на времени.
Фотодиоды, фототранзисторы — рабочие и прикладные схемы
Фотодиоды и фототранзисторы — это полупроводниковые устройства, у которых на их p-n-полупроводниковый переход свет попадает через прозрачную крышку, так что внешний свет может реагировать и вызывать электрическую проводимость через переход.
Как работают фотодиоды
Фотодиод похож на обычный полупроводниковый диод (пример 1N4148), состоящий из p-n-перехода, но он имеет этот переход, освещенный светом через прозрачный корпус.
Его работу можно понять, представив стандартный кремниевый диод, подключенный с обратным смещением к источнику питания, как показано ниже.
В этом состоянии через диод не протекает ток, за исключением очень небольшого тока утечки.
Однако предположим, что у нас есть тот же диод со снятой или удаленной внешней непрозрачной крышкой, подключенный к источнику обратного смещения. Это приведет к освещению PN-перехода диода, и через него будет мгновенно протекать ток в ответ на падающий свет.
Это может привести к прохождению через диод тока до 1 мА, что приведет к повышению напряжения на R1.
Фотодиод, показанный на рисунке выше, можно также подключить со стороны заземления, как показано ниже. Это приведет к противоположному отклику, что приведет к уменьшению напряжения на R1, когда фотодиод освещен внешним светом.
Все устройства на основе P-N перехода работают одинаково и при воздействии света демонстрируют фотопроводимость.
Схематический символ фотодиода можно увидеть ниже.
По сравнению с фотоэлементами на основе сульфида кадмия или селенида кадмия, таких как LDR, фотодиоды, как правило, менее чувствительны к свету, но их реакция на световые изменения намного быстрее.
По этой причине фотоэлементы, такие как LDR, обычно используются в приложениях, использующих видимый свет, и где время отклика не должно быть быстрым. С другой стороны, фотодиоды специально выбираются в приложениях, где требуется быстрое обнаружение источников света, в основном в инфракрасной области.
Вы найдете фотодиоды в таких системах, как инфракрасные цепи дистанционного управления, реле прерывания луча и цепи охранной сигнализации.
Есть еще один вариант фотодиода, который использует сульфид свинца (PbS), и его рабочие характеристики очень похожи на LDR, но предназначены для реагирования только на свет инфракрасного диапазона.
Фототранзисторы
На следующем изображении показан схематический символ фототранзистора
Фототранзистор обычно представляет собой биполярный кремниевый транзистор NPN, заключенный в крышку с прозрачным отверстием.
Он работает, позволяя свету достигать PN-перехода устройства через прозрачное отверстие. Свет вступает в реакцию с открытым PN переходом устройства, инициируя действие фотопроводимости.
Фототранзистор в основном сконфигурирован с неподключенным базовым выводом, как показано на следующих двух схемах.
На левом рисунке соединение фактически приводит к тому, что фототранзистор находится в ситуации обратного смещения, так что теперь он работает как фотодиод.
Здесь ток, генерируемый из-за света на клеммах коллектора базы устройства, напрямую возвращается к основанию устройства, что приводит к нормальному усилению тока и току, протекающему на выходе из клеммы коллектора устройства. .
Этот усиленный ток вызывает пропорциональное напряжение на резисторе R1.
Фототранзисторы могут показывать одинаковые величины тока на своих выводах коллектора и эмиттера из-за разомкнутого соединения базы, и это предотвращает отрицательную обратную связь устройства.
Благодаря этой особенности, если фототранзистор подключен, как показано в правой части рисунка выше, с R1 между эмиттером и землей, результат будет точно таким же, как и для левой конфигурации. Значение для обеих конфигураций, напряжение, развиваемое на R1 из-за проводимости фототранзистора, одинаково.
Разница между фотодиодом и фототранзистором
Хотя принцип работы обоих аналогов схож, между ними есть несколько заметных различий.
Фотодиод может быть рассчитан на работу с гораздо более высокими частотами в диапазоне десятков мегагерц, в отличие от фототранзистора, который ограничен только несколькими сотнями килогерц.
Наличие клеммы базы в фототранзисторе делает его более выгодным по сравнению с фотодиодом.
Фототранзистор можно преобразовать для работы как фотодиод, соединив его базу с землей, как показано ниже, но фотодиод может не работать как фототранзистор.
Еще одно преимущество клеммы базы состоит в том, что чувствительность фототранзистора можно регулировать путем введения потенциометра через базовый эмиттер устройства, как показано на следующем рисунке.
В приведенной выше схеме устройство работает как фототранзистор с переменной чувствительностью, но если соединения потенциометра R2 удалены, устройство действует как обычный фототранзистор, а если R2 замыкается на массу, то устройство превращается в фотодиод.
Выбор резистора смещения
На всех схемах, показанных выше, выбор значения R1 обычно представляет собой баланс между усилением напряжения и характеристикой полосы пропускания устройства.
По мере увеличения значения R1 коэффициент усиления по напряжению увеличивается, но полезный рабочий диапазон полосы пропускания уменьшается, и наоборот.
Кроме того, значение R1 должно быть таким, чтобы устройства были вынуждены работать в своей линейной области. Это можно сделать методом проб и ошибок.
Практически для рабочего напряжения от 5 В до 12 В в качестве R1 обычно достаточно любого значения от 1 кОм до 10 кОм.
Фототранзисторы Дарлингтона
По своей внутренней структуре они похожи на обычный транзистор Дарлингтона.Внутри они построены с использованием двух транзисторов, соединенных друг с другом, как показано на следующем схематическом изображении.
Характеристики чувствительности фототранзистора Дарлингтона могут быть примерно в 10 раз выше, чем у обычного фототранзистора. Однако рабочая частота этих устройств ниже, чем у обычных типов, и может быть ограничена лишь несколькими десятками килогерц.
Фотодиод Фототранзистор Приложения
Лучший пример применения фотодиода и фототранзистора может быть в области приемников световых сигналов или детекторов в волоконно-оптических линиях передачи.
Световая волна, проходящая через оптическое волокно, может эффективно модулироваться как аналоговыми, так и цифровыми методами.
Фотодиоды и фототранзисторы также широко используются для изготовления каскадов детекторов в оптопарах, устройствах прерывания инфракрасного светового пучка и устройствах охранной сигнализации.
Проблема при разработке этих схем заключается в том, что интенсивность света, падающего на фоточувствительные устройства, может быть очень сильной или слабой, а также они могут столкнуться с внешними помехами в виде случайного видимого света или инфракрасных помех.
Чтобы противостоять этим проблемам, эти прикладные схемы обычно работают с оптическими линиями связи, имеющими определенную инфракрасную несущую частоту. Кроме того, входная сторона приемника усилена предусилителем, так что даже самый слабый из оптических сигналов связи легко обнаруживается, что позволяет системе работать в широком диапазоне чувствительности.
Следующие две прикладные схемы показывают, как можно обеспечить надежную реализацию с использованием фотодиодов с несущей частотой модуляции 30 кГц.
Это схемы аварийной сигнализации на основе фотодиодов на основе селективного предусилителя, которые будут реагировать на определенную полосу частот, обеспечивая надежную работу системы.
В верхнем дизайне L1, C1 и C2 отфильтровывают все другие частоты, кроме предполагаемой частоты 30 Гц, из инфракрасного оптического канала. Как только это обнаруживается, он дополнительно усиливается Q1, и его выход становится активным для срабатывания системы сигнализации.
В качестве альтернативы систему можно использовать для активации тревоги при отключении оптического канала.В этом случае транзистор может оставаться активным постоянно с помощью ИК-фокуса 30 Гц на фототранзисторе. Затем выходной сигнал транзистора можно инвертировать с помощью другого каскада NPN, чтобы прерывание ИК-луча 30 Гц отключало Q1 и включает второй транзистор NPN. Этот второй транзистор должен быть интегрирован через конденсатор емкостью 10 мкФ от коллектора Q2 в верхней цепи.
Функционирование нижней схемы аналогично транзисторной версии, за исключением диапазона частот, который составляет 20 кГц для этого приложения.Это также избирательная система обнаружения предусилителя, настроенная на обнаружение ИК-сигналов с частотой модуляции 20 кГц.
Пока ИК-луч, настроенный на 20 кГц, остается сфокусированным на фотодиоде, он создает более высокий потенциал на инвертирующем входном выводе 2 операционного усилителя, который превышает выходное напряжение делителя потенциала на неинвертирующем выводе операционного усилителя. Это приводит к тому, что выходное среднеквадратичное значение операционного усилителя становится близким к нулю.
Однако момент прерывания луча вызывает внезапное падение потенциала на выводе 2 и увеличение потенциала на выводе 3.Это мгновенно повышает среднеквадратичное значение напряжения на выходе операционного усилителя, активируя подключенную систему сигнализации.
C1 и R1 используются для обхода любого нежелательного сигнала на землю.
Используются два фотодиода D1 и D2, поэтому система активируется только тогда, когда ИК-сигналы прерываются одновременно через D1 и D2. Идея может быть использована в местах, где требуется обнаруживать только длинные вертикальные цели, такие как люди, в то время как более короткие цели, такие как животные, могут проходить свободно.
Для реализации этого D1 и D2 должны быть установлены вертикально и параллельно друг другу, при этом D1 может быть расположен на высоте одного фута над землей, а D2 — на расстоянии трех футов над D1 по прямой линии.




 Такой подход оправдан практически, поскольку область эмиттера n-типа специально легируется очень сильно, чтобы обеспечить большое число свободных электронов, в то время как область базы легируется совсем слабо, и это дает настолько мало дырок, что ими можно пренебречь при рассмотрении тока через переход база-эмиттер. Эмиттер так сильно легирован, что напряжение лавинного пробоя перехода база-эмиттер обычно всего лишь 6 В. Этот факт нужно иметь в виду при работе с некоторыми переключающими схемами, где необходимо позаботиться о том, чтобы обратные смещения не были слишком большими. Но это обстоятельство может быть и полезным, поскольку переход база-эмиттер маломощного транзистора ведет себя как 6-вольтовый стабилитрон и иногда используется в этом качестве.
Такой подход оправдан практически, поскольку область эмиттера n-типа специально легируется очень сильно, чтобы обеспечить большое число свободных электронов, в то время как область базы легируется совсем слабо, и это дает настолько мало дырок, что ими можно пренебречь при рассмотрении тока через переход база-эмиттер. Эмиттер так сильно легирован, что напряжение лавинного пробоя перехода база-эмиттер обычно всего лишь 6 В. Этот факт нужно иметь в виду при работе с некоторыми переключающими схемами, где необходимо позаботиться о том, чтобы обратные смещения не были слишком большими. Но это обстоятельство может быть и полезным, поскольку переход база-эмиттер маломощного транзистора ведет себя как 6-вольтовый стабилитрон и иногда используется в этом качестве.


 Этот относительно большой ток утечки является той причиной, по которой германиевые транзисторы вышли из употребления, за исключением специальных целей, когда требуется малая разность потенциалов на германиевом p-n переходе, смещенном в прямом направлении.
Этот относительно большой ток утечки является той причиной, по которой германиевые транзисторы вышли из употребления, за исключением специальных целей, когда требуется малая разность потенциалов на германиевом p-n переходе, смещенном в прямом направлении.
 Если транзистор по этим данным подходит, можно просмотреть
краткий справочный листок (только для распространенных приборов, например,
КТ502, КТ503,
КТ814, КТ815,
КТ816, КТ817,
КТ818, КТ819,
КТ825,
КТ827, КТ829,
КТ837,
КТ838, КТ846,
КТ940,
КТ961, КТ972,
КТ973,
КТ8101, КТ8102), где приведены только основные параметры транзисторов (которых, впрочем, достаточно для грубых расчетов), фото с цоколевкой,
аналоги и производители. Для более детального изучения характеристик
нужно открыть datasheet, где уже есть графики зависимостей параметров и редко требующиеся характеристики.
Если транзистор по этим данным подходит, можно просмотреть
краткий справочный листок (только для распространенных приборов, например,
КТ502, КТ503,
КТ814, КТ815,
КТ816, КТ817,
КТ818, КТ819,
КТ825,
КТ827, КТ829,
КТ837,
КТ838, КТ846,
КТ940,
КТ961, КТ972,
КТ973,
КТ8101, КТ8102), где приведены только основные параметры транзисторов (которых, впрочем, достаточно для грубых расчетов), фото с цоколевкой,
аналоги и производители. Для более детального изучения характеристик
нужно открыть datasheet, где уже есть графики зависимостей параметров и редко требующиеся характеристики.